Eilen puhuimme sen eduista Intel oli ohi AMD, jossa yksi osa oli juuri innovaatio. Todisteena tästä on Intelin 3D-pinoustekniikka, joka muodostaa tulevaisuuden korkean suorituskyvyn sirut, ei tietenkään ongelmitta. Yritys näyttää löytäneen ratkaisun melkein kaikkiin ongelmiin, joita tämä tekniikka aiheuttaa kutsunsa kautta Intel ODI.
Ennen kuin ryhdymme selittämään, mistä tämä tekniikka koostuu, meidän on ymmärrettävä, mitkä ovat olleet syyt, jotka ovat johtaneet Intelin kehittämiseen, mitkä ovat olleet ongelmia ja missä rajoitukset.

Vain tällä tavalla ymmärrämme koko asian monimutkaisuus ja kuinka yritys on onnistunut ratkaisemaan nämä ongelmat erittäin älykkäästi.

Ensinnäkin, ja mielenterveyden luomiseksi, Intel työskentelee tällä hetkellä kolmella eri pinoamistekniikalla, jotka vaihtelevat vähimmäisestä monimutkaisimpaan: EMIB, Foveros ja CO-EMIB.
Ensimmäinen on ns. 2.5D-tekniikka, toinen on ensimmäinen todellinen 3D-sukupolvi, kun taas jälkimmäisessä yhdistyvät molemmat tarjoamaan paljon monimutkaisempia tuotteita. Vaikka olemme jo nähneet ne erikseen, teemme nopean katsauksen kaikista niistä paikantaaksemme itsemme uudelleen.
Intel EMIB
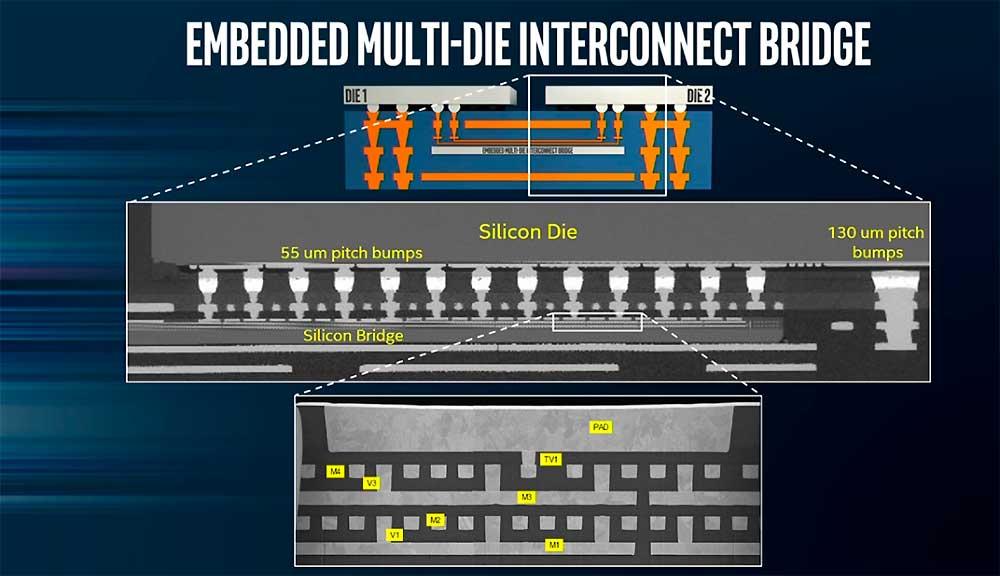
Lyhenne upotetusta MultiInterconnect Bridgestä, se on meille jo tuttu 2.5D-järjestelmä, koska se debytoi Kaby Lake G ja sisälsi Intel-muotin vastaavilla ytimillä, välimuistilla, rekistereillä jne., AMD: lle kuuluvan muotin RX Vega M: n ja 4 Gt: n HBM2-pinon kautta, kaikki yhdessä haastattelijassa, joka oli juotettu kannettavien tietokoneiden emolevyihin.
EMIB on siis keskisuuri yhdistämistekniikka, jonka avulla voit poimia jokaisen välittäjään sisältyvän sirun täyden suorituskyvyn.
Intel Foveros
Se on ensimmäinen askel vallankumouksessa, jonka todistamme, todellinen 3D-pinoaminen. Tämä ei ole muuta kuin erilaisten suuttimien kytkeminen toisiinsa pystysuunnassa, päällekkäin, sen sijaan että vaakatasossa, kuten tähän asti on tehty.
Sitä Intel kutsuu Kasvokkain ja edustaa sarjaa varsin mielenkiintoisia ja samalla hieman loogisia ongelmia. Ensimmäinen on sähköongelma, koska on välttämätöntä tuoda tarpeeksi energiaa ylempään suulakkeeseen ja tehdä tämä, on tarpeen käydä väliväli (t) läpi. Tämä ratkaistiin osittain TSV-puheluilla, mutta nämä eivät ole halukkaita toimittamaan suuria määriä jännitettä ja vaikka lisäämällä tämä voidaan ratkaista, on ongelma, että tällä hetkellä kallein 3D-siru on tarkkaan lisääminen TSV laadusta ja määrästä.
Viimeinkin Intel kohtaa lämpötila-ongelman. Ylempi muotti voidaan jäähdyttää, mutta samalla se edustaa alempien lämpöresistenssiä, koska jokaisessa pystysuunnassa yläosa estää lämmön siirtymisen ja aiheuttaa ketjuongelman.
Intel CO-EMIB
Periaatteessa kyse on EMIB: n ja Foverosin välisestä sulautumisesta, jota kutsutaan jollain puhekielisellä tavalla. Se on 3D-pinoaminen, jossa käytetään vaakasuuntaista pituutta, ja siten lievittää jollakin tavalla molempien ongelmia, mutta ei ratkaise niitä.
Joten Intel joutui keksimään uuden tekniikan, joka oli yhteensopiva kaikkien kolmen sen pakkausmallin kanssa, ja samaan aikaan lopettamaan kaikki ongelmat, joista olemme puhuneet, ja juuri tässä ODI tulee.
Intel ODI
ODI on lyhenne sanasta Kokosuuntainen yhdys eikä se ole itsessään tekniikka, vaan joukko heistä, ts. ODI käsittää joukon erityisiä ratkaisuja, jotka saattavat kasvaa ajan myötä tai kehittyä sellaisenaan.
Sen päätoiminto perustuu sähkönjakeluun ja sen tarkoituksena on lopettaa EMIB: n ja Foverosin ongelmat, koska tämän tekeminen oletusarvoisesti lopettaa CO-EMIB: n ongelmat.


Kaikki perustuu siihen, mitä Intel kutsuu 3D-pakkaus virtaa , jotka ovat vain sisäisiä kytkentäreittejä energian saapumisen parantamiseksi ja samalla lämmön haihtumisen parantamiseksi yhden tyyppisellä tekniikalla.


Tällä hetkellä Intel ODI on jaettu osiin kaksi yleistä tyyppiä ja nämä puolestaan muuttuvat toisiaan täydentäväksi tekniikaksi, mikä tekee yhteensä neljä vaihtoehtoa. Tyyppi 1 -vaihtoehto keskittyy alemman ja ylemmän muottien välisiin ongelmiin, kun taas tyyppi 2 tekee niin alempien suuttimien välillä, jotka ovat vertikaalisesti täysin ylämuotin alapuolella.
Toisin sanoen Foveros-paketti ja CO-EMIB-paketti, johon Intel EMIB tulee loogisesti. Selittänyt tämän, menemme eri tyyppien kanssa syvemmälle.
Intel ODI tyyppi 1
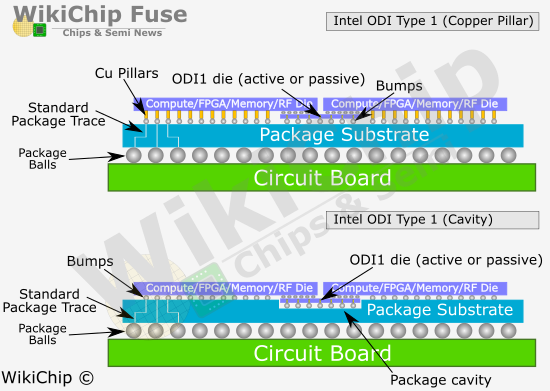
Ensimmäinen asia, jonka meidän on kuviteltava, on se, että muotit, joista aiomme puhua, ovat erikokoisia, mikä on tärkeää, koska tapa yhdistää ne toisiinsa mittojensa vuoksi. Tämän mielessä meidän on kuviteltava suurempi suulake, joka on kahden pienemmän ylämuotin alapuolella, tai äärimmäisessä tapauksessa se on suurempi suulake, joka on toisen pienemmän suulakkeen alapuolella, joka ei loogisesti kata kaikkea ala-aluetta.
Jotta enemmän tai vähemmän yksinkertainen samanvertaisuus saadaan, se on pyramidivaikutus: alaosan pohja on aina suuremman alueen kuin ylempi, sillä erolla, että tässä on vain yksi muotti ja päällä siinä voi olla pienempi tai useampi, mutta ne eivät koskaan ole yhtä suuria kuin alaosa.
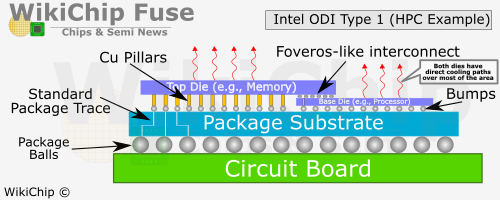
Tämän etuna on, että Intel on suunnitellut järjestelmän siten, että alamuotti peittää vain sen osan ylemmästä suulakkeesta, missä niiden välinen liittäminen vaaditaan. Syynä tähän on logiikka: poistat TSV-autojen haitat ja pidät kaikki Foveros-tuotteet. Koska käytetään vain sitä osaa muottien välisestä liitosta, Intel voi tehdä aktiivisen tai passiivisen tyypin 1 ODI: n.
Tämä tarkoittaa, että passiivisuuden ollessa kyseessä vain rajoittuu molempien suuttimien väliseen liittoon, mutta jos se on aktiivinen, se toimii yhdistävänä tiedonsiirtona, joka on erittäin hyödyllinen, jos haluat lisätä HBM pinot ulkoiseen välimuistiin tai iGPU . Siksi palaamalla mentiaaliseen järjestelmään, jos ODI 1: llä käytetään useita erikokoisia kuolemia, kaikilla niillä on pääsy parempaan lämmönpoistoon, missä IHS: n on oltava joissain tapauksissa erityinen, mutta pääsy saavutetaan. suoraan siihen ja siksi lämpöongelmat on ratkaistu.
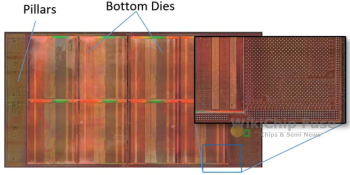
Tämä on tärkeää, koska jos tarkasteltaisiin molempia suulakkeita zenith-näkymästä, niistä olisi vain osa, jotka olisivat kytkettyinä, välttämätön, kun taas loput muotit ovat riippumattomia ja pysyvät ilmassa kussakin tapauksessa kaksi erilaista korkeutta tietenkin ja juuri se erottaa sen EMIB: stä tekniikkana.
Puhumattakaan siitä, että molempien suuttimien välinen liitos on tehtävä muun muassa termisellä puristuksella.
Intel ODI tyyppi 2
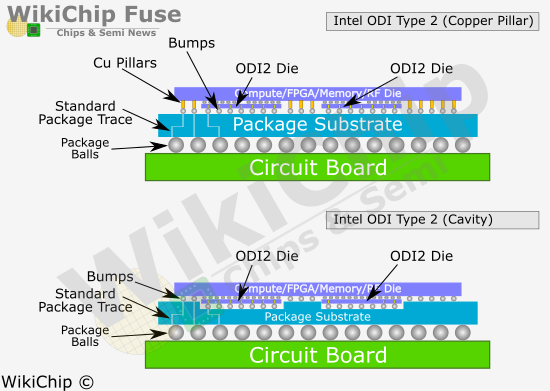
Tässä ongelma kasvaa, koska alempi muotti on aina ylemmän suulakkeen alapuolella, toisin sanoen, muotissa ei ole mitään osaa, joka olisi sen alapuolella, joka työntyisi yläpuolelta. Tämä tuo lämmön haittapuolen, mutta samalla sillä on selkeämpi etu: alempi muotti voidaan sijoittaa tarkalleen missä vaaditaan verrattuna ylempään muottiin ja liitosten lukumäärä voi olla paljon suurempi.
Tämä tekniikka on keskittynyt sulakkeiden välisten suorituskyky- ja yhteysongelmien lievittämiseen, joissa esimiehen suorituskyky on aina maksimoitu, kuten parempia tulo- ja lähtöyhteyksiä, nopeampi välimuisti, ulkoistaminen heitä ilman rangaistusta ja loputtomia. mahdollisuuksista.
Voisit tehdä Zen 2-tyylisen I / O: n, jolloin välimuistit poistuvat ytimistä erilaisissa suuttimissa, tekemällä ehjistä ytimistä ja kolmella eri tasolla menettämättä suorituskykyä, koska ne ovat suoraan yhteydessä toisiinsa fyysisten liitosten kautta TSV: n kanssa. Tämän edut ovat niin ilmeisiä, että on järjetöntä edes kommentoida niitä.
Tässä ongelmana on lämpötila, mutta tyypin 2 ODI: n tarkoituksena on sijoittaa pienimmällä energiankulutuksella varustettu muotti alaosaan ja skaalata pystysuoraan, kunnes enemmän lämpöä tuottavat muotit asetetaan ylempään kerrokseen, jotta voidaan jäähdytetään IHS: n kanssa, mikä antaa todella upeita prosessori konfigurointivaihtoehtoja ja mahdollistaa erottelun osallistavan tehokkuuden saavuttamiseksi.
Kuten olemme sanoneet, ODI Type 1 ja Type 2: lla on kaksi erilaista versiota: Kuparipilari ja ontelo , jossa ensimmäisessä käytetään kuparipylväitä suuremman korkeuden kompensoimiseksi, kun taas toisessa substraatti muottui alamuottiin, jolloin pylväiden sijaan voidaan käyttää kohoumia.
Intel ODI voi sekoittaa molemmat tyypit tarjotakseen monimutkaisempia suorittimia
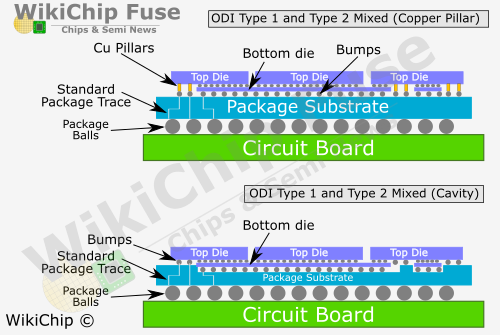
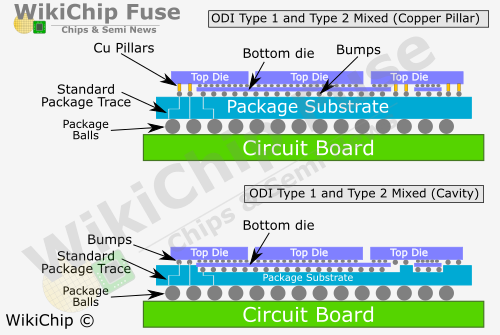
Toinen etuna ODI: stä tekniikkana on, että se ei ole yksinoikeus, eli molempia tyyppejä voidaan käyttää niiden kahden version kanssa samassa prosessorissa. Siksi modulaarisuus että voimme nähdä tulevaisuuden keskusyksiköissä, ovat niin kalliita, että suunnittelun monimutkaisuus tulee olemaan Intelin suurin haaste.
Ilmeisin kysymys on samalla kaikkein asiaankuuluvin: milloin näemme nämä prosessorit markkinoilla? Todella vaikea vastaus kysymykseen. Muista, että ODI tekniikkana on vain muutama kuukausi, sitä ollaan parhaillaan toteuttamassa ja sitä on parannettava prosessin yksinkertaistamiseksi, mutta Intel on uskaltanut tarjota likimääräiset päivämäärät: 2022 tai 2023.
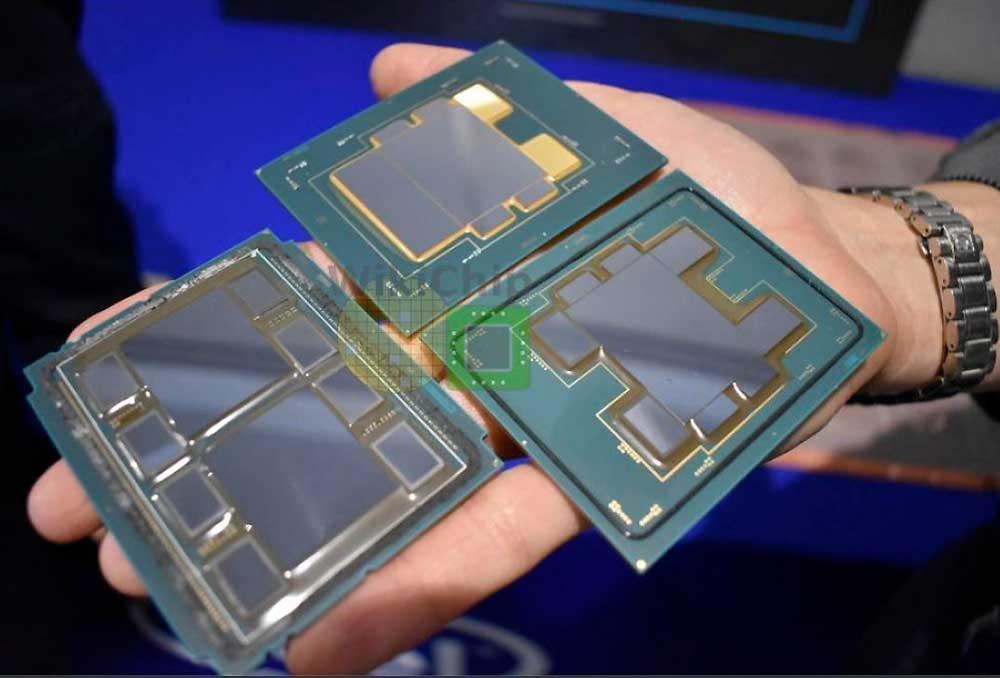
ODI teknologiana onnistuu lyhentämään määräaikoja, koska se ratkaisee kolmen Intel-tekniikan kaksi pääongelmaa, joten ensimmäiset prosessorit (niiden ei selvästikään tarvitse olla työpöydälle) voitiin nähdä tuotannossa vuonna 2024, koska ne olivat todella optimistisia , koska kuten usein tapahtuu, ensin julkaistaan vähemmän tehokkaita versioita ja kun sekä prosessi että tuotanto hiotaan ja parannetaan, tarjotaan korkealaatuinen versio.
Joka tapauksessa, tämä ei ole tieteiskirjallisuutta, tämä on todellisuus, tuntuva, joka on jo ollut markkinoilla Kaby Lake G ja Stratix 10 ja joka on epäilemättä prosessorien tulevaisuus, mikä on huomattavasti suurempi vallankumous kuin monimuotti tai MCM monimutkaisuutensa vuoksi, on lopullinen askel, jotta pystytään lieventämään seinää, jonka löydämme litografisista prosesseista vuonna 2030 ja se voi olla epäilemättä edellinen vaihe monimutkaisempien tekniikoiden luomiseen, jotka jättävät markkinoilla nykyisen vaipat.