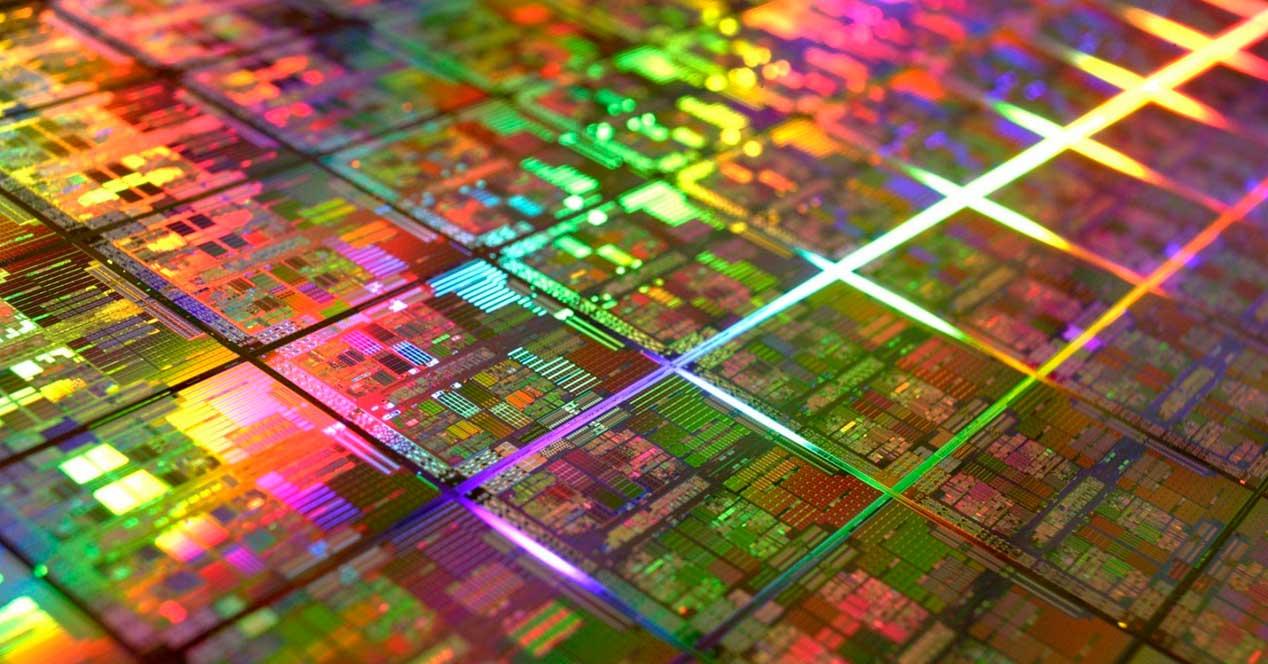
Æraen med wafer-dybning og ætsning er officielt forbi, og mens det er Intel er stadig noget bagud, når det kommer til de teknologier, der anvendes i EUV, deres køreplan inkluderer dem meget tydeligt. Samsung og TSMC arbejder allerede med EUV-mønstre, men branchen er virkelig bekymret, da der er udfordringer med at nå 3 nm og især til lavere noder. Hvordan vil du oprette det nyeste CPU og GPU-perfekte litografiske processer? Med EUV High-NA .
Er det muligt og muligt i dag at reducere størrelsen af transistorer under de nævnte 3 nm? Branchen åbner flere fronter med ASML i spidsen, mens mange andre undrer sig over, hvordan vi skal skabe masker til så små bølgelængder. Hvad er problemerne?
Nye scannere, nye modstandsprocesser og masker med EUV High-NA

Der er tre hoved søjler til wafer gravering i dag og i de kommende år: scannere leveret af ovennævnte ASML, modstandene til maskerne og selve maskerne.
Hvorfor er scannere et problem? Primært fordi det er virkelig kompliceret at reducere bølgelængden på 193 nm, da du har brug for en 0.33 numerisk blænde (NA) linse med opløsninger på 13 nm og med den højest mulige ydelse pr. wafer.
EUV er en teknologi, der arbejder med laserimpulser, der rammer små dråber tin i meget høj hastighed, hvilket genererer fotoner, og disse spretter af forskellige spejle inde i scanneren for at ende med at blive reflekteret på masken og derefter på waferen og forme transistorer.
Problemet er, at fotonerne ikke ender på waferen, men forbliver i masken eller går direkte tabt rundt om kanterne. Løsningen ville være at bruge film, der beskytter waferen, men teknologien er ikke klar, så skubbet af konkurrencen er alle blevet skudt til at optage ved 193 nm uden dem, hvilket er muligt ved 7 nm og fremtidig 5 nm.
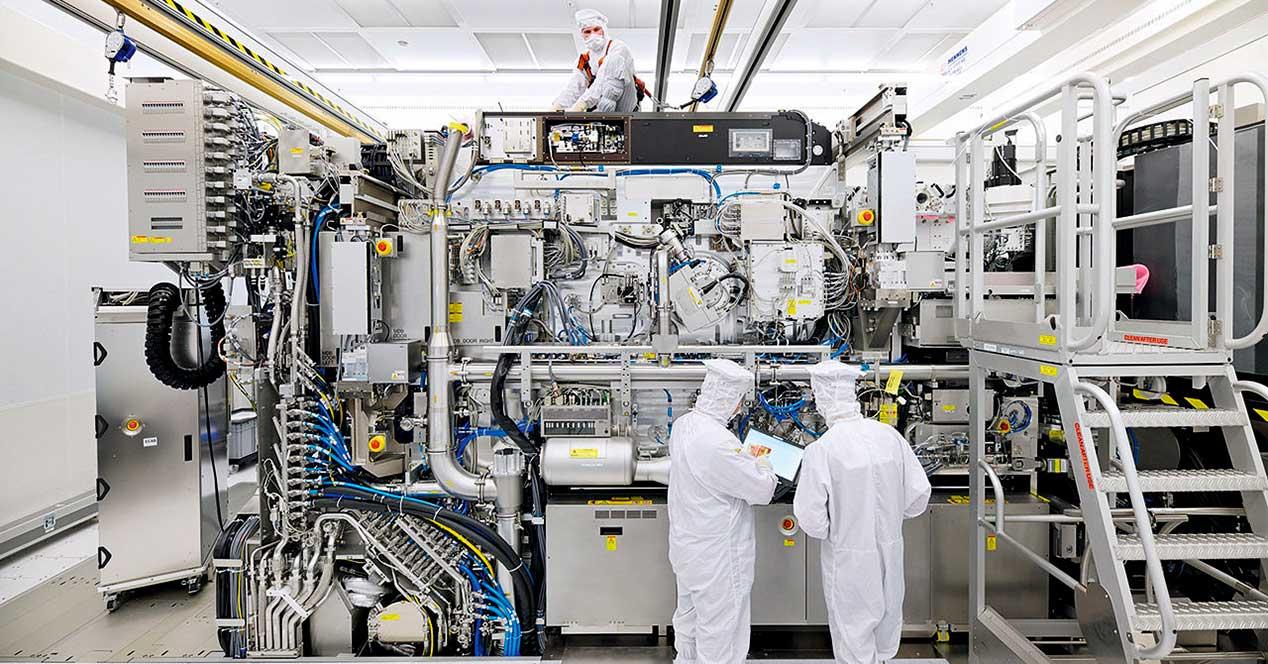
Og det er fordi der bruges et simpelt og ikke flere mønstre, da det kan have en tonehøjde på 32 nm eller 30 nm, men at reducere det indebærer at skifte scannere til at nå 3 nm eller mindre. Svaret kommer tilbage til ASML med en 0.55 NA scanner, der er i stand til at optage ved 8 nm opløsninger, et gigantisk fremskridt.
Disse scannere kaldes daglig Høj-NA og vil give mulighed for at vende tilbage til det unikke designmønster, reducere omkostninger og gradvist øge wafere i timen. Problemet er, at for dem at arbejde kræves der to masker og ikke en, der skal sys sammen til en wafer på grund af deres kompleksitet.
Dette vil hæve omkostningerne, hvilket allerede er uoverkommeligt i dag, da f.eks. En nuværende EUV-scanner er forbi 153 millioner dollars , mens High-NA vil være forbi 318 millioner . Betyder det, at processorer vil stige i pris såvel som GPU'er? Det er meget sandsynligt, hvis de ikke finder en løsning.
Modstandene til waferne er også i en blindgyde

Før der oprettes et mønster til en wafer, indsættes det i et system kaldet en coater, hvorefter fotoresistmaterialer hældes i waferen, som roterer for at efterlade et ensartet lag for at beskytte det.
Derefter ankommer graveringen i litografiscanneren, så det er en meget vigtig indledende proces. I øjeblikket er der to systemer til at gøre dette i EUV: kemisk forstærket eller BIL og dem, der er baseret på den såkaldte metaloxid.
Problemet med biler er, at de lider af sløring af scannerlinsen, hvilket ikke tillader så høje opløsninger i disse, for ikke at nævne dem, der følger med NA. Metaloxidmodstande er mere egnede til disse fejl, men de er mindre stabile, derfor er der intet system, der er 100% pålideligt og frem for alt rentabelt.
Imidlertid arbejdes der på et system kaldet tør fotoresist, et system til fjernelse af fugt og forbedring af opløsning og stabilitet ved belægning i et tørt behandlingskammer før eksponering for fotoner. Dette gælder for EUV og EUV NA, men det vil tage et par år at ankomme.
Fotomasker bliver heller ikke skånet og skal forbedres
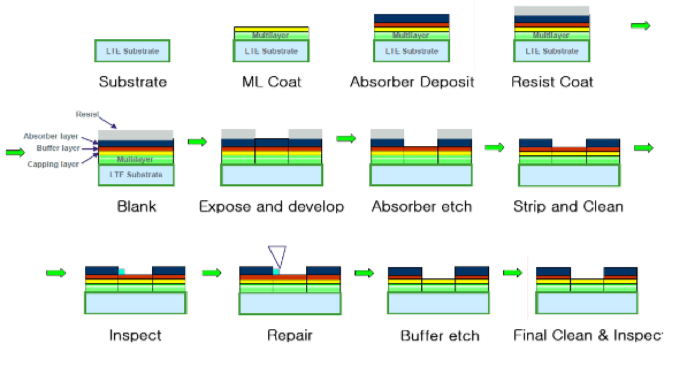
En nuværende EUV-maske består af mellem 40 og 50 tynde lag silicium og molybdæn på et substrat, hvilket giver en samlet tykkelse, der normalt er mellem 250 nm og 350 nm. Hver maske har en komponent kaldet ”absorber”, som forhindrer lys, der springer fra skiven og hjælper med en mere perfekt ætsning.
Problemet er, at lyset i et EUV-system når masken i en vinkel på 6 º , hvilket forstærker det faktum, at det reflekteres, og det absorberende stof ikke kan udføre alt arbejdet, hvilket medfører mulige ændringer i placeringen i mønstrene med den deraf følgende forringelse af skiven.
Hvordan løses dette? Med finere absorberende stoffer. De nuværende er 60 nm og de bedste og dyreste 50 nm, men de er ikke i stand til at ordne dette og mindre ved mindre og højere bølgelængder. Af denne grund skaber forskere to nye typer masker til fremtidige litografiske processer i EUV: så - kaldet High-K og Phase-Shift.
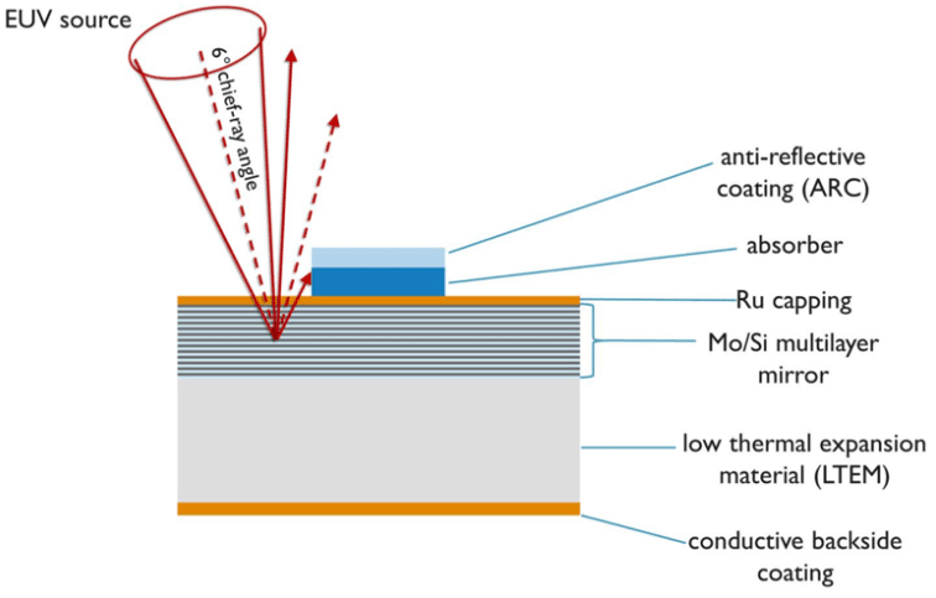
Sidstnævnte er de enkleste, fordi det kun kræver ændring af det absorberende materiale til en med lav-N egenskaber, idet man undgår tantal. Det, der søges, er at blokere lyset og forhindre det i at blive reflekteret, opnå mørke områder og derfor forbedre billedernes præcision med mere grundlæggende kontrast.
Meget lidt er kendt om High-K, men det ser ud til, at de kan repareres med en laser, hvilket sænker de endelige produktionsomkostninger, da maskerne er ekstremt dyre, og en er nødvendig for hvert mønster.
Sammenfattende er 7 nm og 5 nm garanteret, men går ned til 3 nm er bliver ikke så let på trods af, at både Samsung og TSMC og Intel hævder at have dem klar i 2025 i værste fald.
