Včera jsme hovořili o výhodách, které to přináší Intel skončila AMD, kde jednou ze sekcí byla právě inovace. Důkazem toho je to, co společnost Intel představila pro svou technologii 3D stohování, která bude tvořit vysoce výkonné čipy budoucnosti, samozřejmě bez problémů. Zdá se, že společnost našla řešení téměř všech problémů, které tato technologie přináší prostřednictvím toho, co nazvala Intel ODI.
Než se podíváme na vysvětlení toho, z čeho tato technologie sestává, musíme pochopit, jaké důvody vedly Intel k jejímu vývoji, jaké byly problémy a kde byla omezení.

Pouze tak můžeme pochopit složitost celé této záležitosti a to, jak se společnosti podařilo tyto problémy vyřešit velmi inteligentním způsobem.

Za prvé, a aby vytvořil mentální schéma, Intel v současné době pracuje se třemi různými stohovacími technologiemi, které sahají od nejméně po nejsložitější: EMIB, Foveros a CO-EMIB.
První je tzv. Technologie 2.5D, druhá je první skutečnou 3D generací, zatímco druhá kombinuje oba a nabízí mnohem složitější produkty. Přestože jsme je již viděli samostatně, provedeme rychlou revizi všech, abychom se znovu postavili.
Intel EMIB
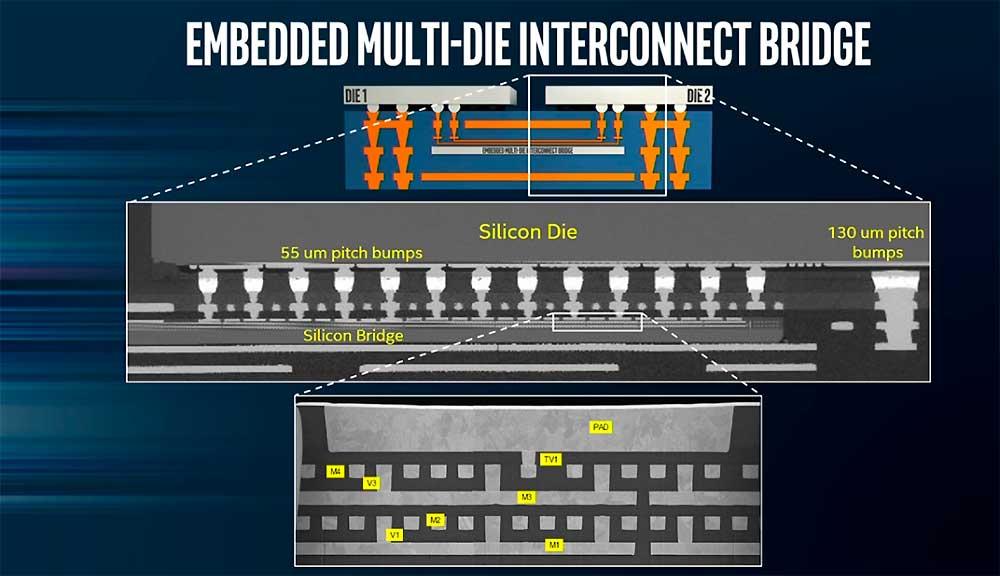
Zkratka pro Embedded MultiInterconnect Bridge, to je 2.5D systém, který je nám již známý, protože debutoval s Kaby Lake G a zahrnoval lisovník Intel s odpovídajícími jádry, vyrovnávací pamětí, registrami atd.…, lisovník patřící AMD prostřednictvím RX Vega M a hromady HBM4 s kapacitou 2 GB, vše v jediném interposeru, který byl pájen na základní desky notebooku.
EMIB je proto technologie propojení ve středním měřítku, která vám umožňuje extrahovat plný výkon každého čipu, který je součástí interposeru.
Intel Foveros
Je to první krok v revoluci, kterého budeme svědky, skutečné 3D stohování. To není nic jiného než propojení různých forem svisle, jedna na druhé, namísto vodorovně, jak tomu bylo doposud.
To je to, co Intel volá Z očí do očí a představuje řadu docela zajímavých a zároveň poněkud logických problémů. Prvním je elektrický problém, protože je nutné přivést dostatek energie do horní formy a za tímto účelem je nutné projít mezilehlým. To bylo částečně vyřešeno pomocí volání TSV, ale ty se zdráhají dodávat velké množství napětí, a ačkoli přidáním tohoto více lze vyřešit, je problém, že nejdražší 3D čip v současné době je přesné přidání TSV kvality a objemu.
Nakonec Intel čelí problému s teplotou. Horní tryska může být chlazena, ale zároveň představuje tepelný odpor pro dolní trysky, protože u každé vertikální trysky horní tryska brání přenosu tepla a způsobuje řetězový problém.
Intel CO-EMIB
Jde v zásadě o fúzi, která se nazývá určitým hovorovým způsobem, mezi EMIB a Foveros. Jedná se o 3D stohování, kde se používá horizontální délka, a proto nějakým způsobem zmírňuje problémy obou, ale neřeší je.
Intel tedy musel přijít s novou technologií, která je kompatibilní se všemi třemi jejími modely balení a zároveň ukončit všechny problémy, o nichž jsme mluvili, a právě tam přichází ODI.
Intel ODI
ODI je zkratka pro Všesměrové propojení a není to technologie sama o sobě, ale jejich skupina, to znamená, že ODI zahrnuje řadu specifických řešení, která se mohou postupem času zvyšovat nebo se jako taková vyvíjet.
Jeho hlavní funkce je založena na dodávce energie a jejím cílem je ukončit problémy EMIB a Foveros, protože to ve výchozím nastavení ukončí problémy CO-EMIB.


Vše je založeno na tom, co společnost Intel volá 3D balení toky , které nejsou ničím jiným než vnitřními propojovacími cestami ke zlepšení příchodu energie a současně ke zlepšení odvodu tepla pomocí jediného typu technologie.


V současné době je Intel ODI rozdělen do dva obecné typy a tyto zase na dvě doplňkové technologie, takže celkem čtyři varianty. Varianta typu 1 se zaměřuje na problémy mezi spodními a horními raznicemi, zatímco typ 2 to dělá mezi dolními raznicemi, které jsou, vertikálně řečeno, zcela pod horním razičem.
To znamená balíček Foveros a balíček CO-EMIB, kam logicky vstoupí Intel EMIB. Vysvětlil to, že jdeme s různými typy do hloubky.
Intel ODI typ 1
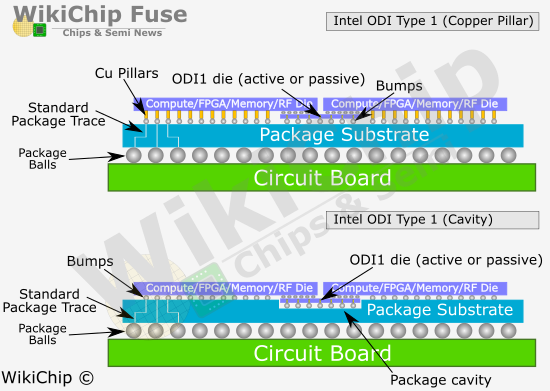
První věc, kterou si musíme představit, je, že matrice, o které budeme mluvit, mají různé velikosti, což je důležité, protože způsob jejich propojení se liší v závislosti na jejich rozměrech. S ohledem na to si musíme představit větší zápustku, která je pod dvěma menšími horními zápustkami, nebo v nejextrémnějším případě jde o větší zápustku pod jinou menší zápustku, která logicky nepokrývá celou dolní oblast.
Jde-li o víceméně jednoduchou podobnost, jedná se o pyramidový efekt: spodní základna má vždy větší plochu než horní, s tím rozdílem, že zde je pouze jedna matrice a nahoře může mít menší nebo více, ale nikdy nedosáhnou tak velké jako spodní.
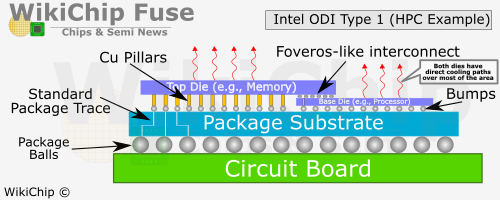
Výhodou toho je, že Intel navrhl systém tak, že spodní matrice pokrývá pouze část horní formy, kde je vyžadováno spojení mezi nimi. Důvod má svou logiku: eliminujete nevýhody TSV a zachováváte všechny nevýhody Foverosu. Protože se používá pouze část spojení mezi razidly, může Intel vytvořit aktivní nebo pasivní ODI typu 1.
To znamená, že v případě, že je pasivní, je omezeno pouze na spojení mezi oběma matricemi, ale pokud je aktivní, funguje jako propojovací datový vysílač, což je velmi užitečné, pokud chcete přidat z HBM komíny do externí mezipaměti nebo iGPU . Proto, a když se vrátíme k mentálnímu schématu, pokud se pomocí ODI 1 použije několik forem různých velikostí, mohou mít všechny přístup k lepšímu rozptylu tepla, kde IHS bude v některých případech specifická, ale přístup je dosažen. přímo na to, a proto jsou vyřešeny teplotní problémy.
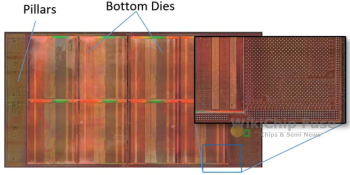
To je důležité, protože pokud bychom se podívali na obě formy ze zenitového pohledu, existovala by jen část z nich, která by byla propojena, základní, zatímco zbytek formy je nezávislý a zůstává ve vzduchu v každém případě, s dvě různé výšky, a to je přesně to, co jej odlišuje od EMIB jako technologie.
Nemluvě o tom, že spojení mezi oběma zápustkami musí být provedeno mimo jiné tepelnou kompresí.
Intel ODI typ 2
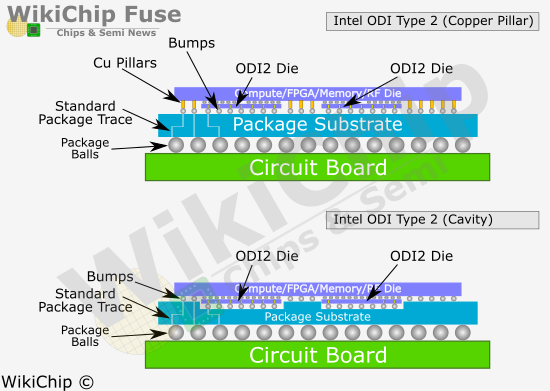
Zde se problém zvyšuje, protože spodní lisovnice je vždy pod horním lisovníkem, to znamená, že neexistuje žádná část lisovnice, která je pod vyčnívající z lisovnice, která je výše. To přináší nevýhodu tepla, ale zároveň má jasnější výhodu: dolní matrice může být umístěna přesně tam, kde je to potřeba, ve srovnání s horní matricí a počet připojení může být mnohem vyšší.
Tato technologie je zaměřena na zmírnění problémů s výkonem a připojením mezi raznicemi, kde je výkon nadřízeného vždy maximalizován, například lepší propojení vstupů a výstupů, vyšší rychlost v mezipaměti, outsourcing je bez trestu a nekonečné. možností.
Dalo by se udělat I / O ve stylu Zen 2 a nechat mezipaměti mimo jádra v jiné matrici, takže by nedotčená jádra a ve třech různých úrovních bez ztráty výkonu, protože jsou přímo k sobě připojeny prostřednictvím fyzických svazků s TSV. Výhody tohoto jsou tak zřejmé, že je absurdní je dokonce komentovat.
Zde je problém v teplotě, ale u ODI typu 2 je zamýšleno umístit matrici s nejnižší spotřebou energie do spodní části a vertikálně škálovat, dokud neumístíte matrice, které generují více tepla do horní vrstvy, aby bylo možné chlazené s IHS, což dává některé opravdu úžasné procesor možnosti konfigurace a umožňuje segregaci pro inkluzivní efektivitu.
Jak jsme řekli, ODI typ 1 a typ 2 mají dvě různé verze: Měděný sloup a dutina , kde v prvním by se měděné sloupy použily k vyrovnání větší výšky, zatímco ve druhém by se substrát vytvaroval do dolní formy, což umožní použít místo sloupků hrboly.
Intel ODI může kombinovat oba typy, aby nabídl složitější CPU
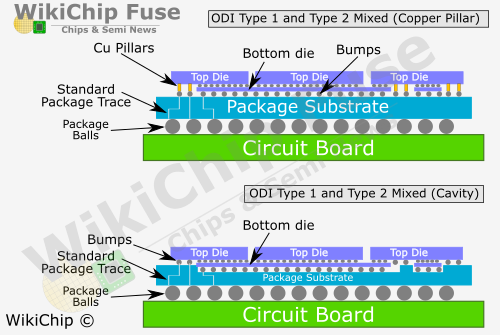
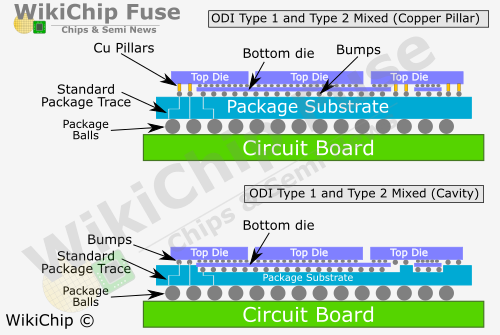
Další výhodou ODI jako technologie je to, že není exkluzivní, to znamená, že oba typy lze použít se svými dvěma verzemi na stejném CPU. Proto, modularita že v CPU budoucnosti uvidíme, je takové ráže, že složitost jeho konstrukce bude pro Intel hlavní výzvou.
Nejviditelnější otázkou je zároveň ta nejvhodnější: kdy uvidíme tyto CPU na trhu? Opravdu obtížná otázka. Mějte na paměti, že ODI jako technologie je stará jen několik měsíců, v současné době se implementuje a musí se zlepšit, pokud jde o zjednodušení procesu, ale společnost Intel se odvážila nabídnout přibližná data: 2022 nebo 2023.
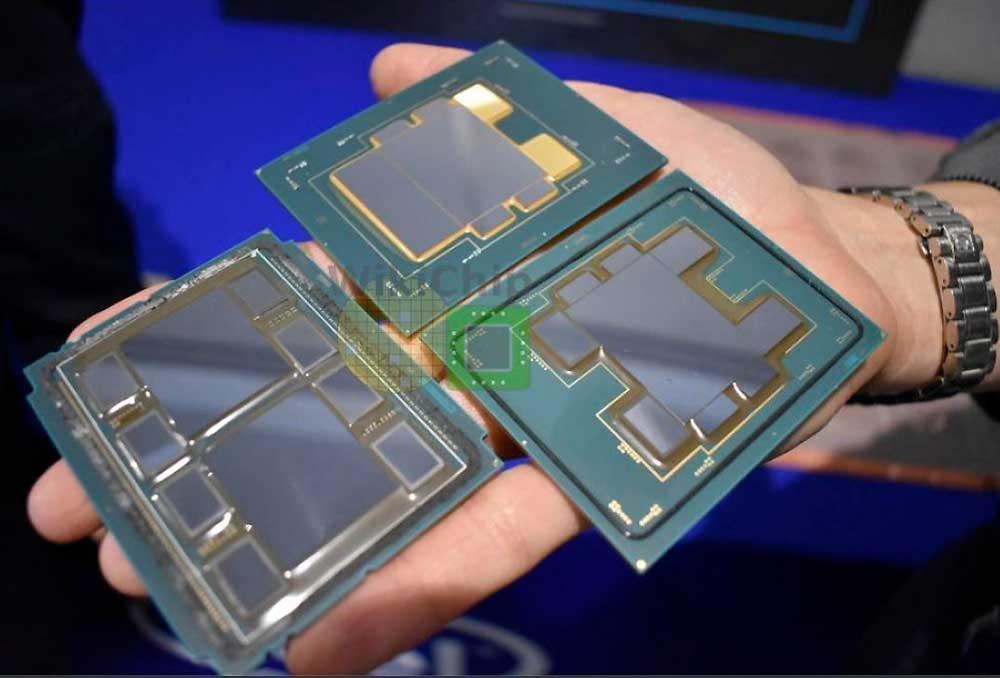
Technologii ODI as se podaří zkrátit termíny, protože řeší dva hlavní problémy tří technologií Intel, takže první procesory (samozřejmě nemusí být pro stolní počítače) mohly být ve výrobě vidět v roce 2024, protože byly skutečně optimistické Od té doby, jak je tomu často, jsou nejprve vydány méně výkonné verze a když jsou jak proces, tak výroba vyleštěny a vylepšeny, nabízí se vysoce výkonná verze.
V každém případě se nejedná o sci-fi, jedná se o realitu, hmatatelnou, s níž se na trhu již setkáváme Kaby Lake G a Stratix 10 a což je nepochybně budoucnost procesorů, což je mnohem větší revoluce než Multi-die nebo MCM kvůli jeho složitosti, je definitivním krokem k tomu, abychom byli schopni zdesitovat zeď, kterou najdeme v litografických procesech zpět v roce 2030, a to může být bezpochyby předchozí krok ke složitějším technologiím, které ponechávají to, co v současné době máme v plenkách na trhu.
