Почти год назад, Intel представила одну из самых актуальных технологий этого десятилетия, а вместе с ней и архитектуру, которая удивила всех подходом и реализацией, которые собираются реализовать синие. Эта архитектура Lakefield , которая была в разработке в течение десятилетий, и что мы будем иметь привилегию созерцать, но что это такое и почему это так революционно?
Подход Intel к этой архитектуре и SoC может показаться сложным, но реальность такова, что ARM вступил, чтобы более или менее достойно конкурировать на рынке серверов и настольных ПК, теперь Intel собирается попытаться напасть на рынок смартфонов, телевизоров и в целом так называемых IoT .

LakeField - это не шаг, а прыжок в будущее из-за того, что он представляет и как он разработан, что в то же время является самой интересной вещью в архитектуре.
Intel LakeField, 3D-реализация достигает фишек будущего

Давайте разместим основные карты на входном столе, чтобы понять тип технологии, на которую мы ссылаемся, и что их перечисление будет легче понять:
- Мы сталкиваемся с мобильный SoC.
- Сверхнизкое потребление ( 2 мВт ).
- Первая настоящая многоядерная архитектура Intel.
- First Пента Ядро в его истории.
- Первый чип компании на основе big.LITTLE концепция.
- Интегрированный Gen 11 iGPU .
- Технология Foveros с трехмерной упаковкой чипов.
- Поддержка LPDDR4X .
- Это займет только 12 x 12 мм 1 мм высота.
Множество концепций, много инноваций и, прежде всего, многолетние разработки, которые станут основой процессоров нового поколения не только от Intel, но и от других производителей. AMD и остальные компании, которые хотят иметь возможность конкурировать. Весь сектор ориентирован на так называемый 3D-пакет, давайте не будем обманывать себя, это будущее и скоро будет настоящее, но чтобы понять это, необходимо понять, как устроено LakeField.
3D-укладка, основа нового поколения штампов
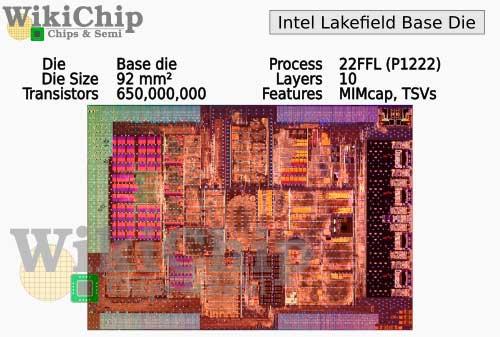
Нетрудно понять концепцию 3D штампов. Это микросхемы, которые вертикально связаны друг с другом с помощью различных технологий, о которых мы уже говорили, таких как EMIB, Foveros или Co-EMIB через ODI.
В LakeField Intel была столь же амбициозной и умной, подложка (матрица) использовалась для всех функций, которые Intel называет «малой потребляемой мощностью». Это включает в себя интерфейс USB-C 3.0, некоторые шины ввода-вывода с более низкой производительностью и особенно интерфейс PCIe Gen 3.
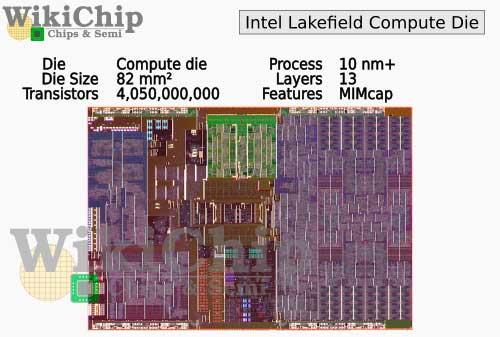
Как хорошая база, он будет больше, чем окончательный размер чипа и может похвастаться 92 mm2 в рамках 22 нм процесса FFL, также называемого 22FFL, который, хотя по своей номенклатуре может показаться не таким, на самом деле это очень специфический процесс для этого типа продуктов, основанный на 14 нм, но оптимизированный для мобильных SoC.
Поэтому транзисторы будут записаны на 14 нм и, таким образом, будут способствовать эффективности всей матрицы. Он дешевый, обладает расширенными возможностями, характерными для этого типа продукта, и имеет меньше слоев, чем обычный кристалл, поэтому у Intel лучше всего экономят свои новые 10 нм и следующие 7 нм, где стоимость все еще очень высока.
Плашка является самой продвинутой на сегодняшний день, созданной Intel.
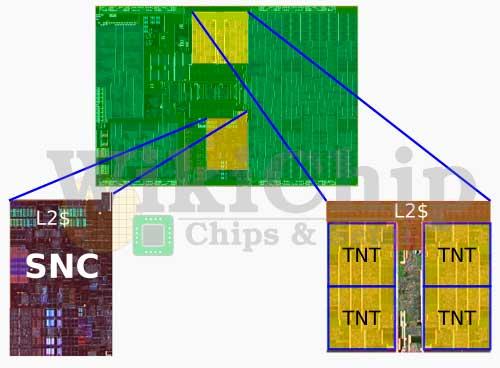
Учитывая его основу, мы собираемся познакомиться с самой матрицей, где есть все преимущества и новинки этой архитектуры и чипа. Речь идет о матрице размером всего 82 мм2 с более чем 4 миллиардами транзисторов, что показывает, что плотность абсолютно брутальная и до сих пор не видна.
Это имеет свое объяснение, и это то, что LakeField прибудет под новым 10 нм + от Intel, то есть второго поколения нового литографического процесса, который значительно увеличивает частоту по сравнению со второй версией и немного улучшает конечную плотность. Здесь следует подчеркнуть, что, по-видимому, 37% чипа будет потрачено на iGPU, что показывает усилия, которые Intel должна приложить к Gen 12, чтобы сделать интегрированные графические карты более мощными и с меньшей конечной площадью в кристалле.
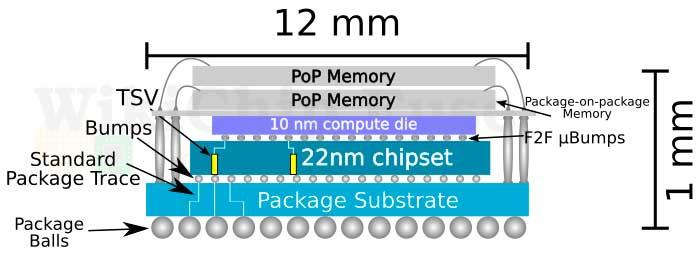
Что касается самих ядер, мы найдем четыре на основе архитектуры Tremont и одну Sunny Cove, где Intel не включила Hyper Threading. Это было сделано таким образом, чтобы облегчить распределение задач в операционных системах, поскольку кажется, что эта технология потребует времени для разработчиков, как ожидается.
Преимущество здесь, с другой стороны, состоит в том, что ядро Tremont на той же частоте, что и Sunny Cove, достигнет до 70% своей производительности, но с бесконечно меньшим потреблением.
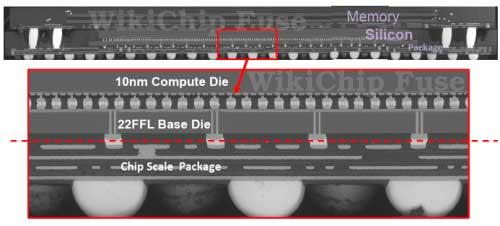
Для этого требуется, чтобы рабочие нагрузки приходили пакетами для самых больших ядер, тогда как фоновые процессы управляются четырьмя ядрами Tremont, что экономит много энергии.
Наконец, все четыре ядра Tremont, по оценкам, аналогичны по размеру ядру Sunny Cove, включая их кеши и инструкции AVX-512 (деактивированы в стандартной комплектации), поэтому мы можем получить представление о потенциале, который могут иметь будущие чипы. почти в той же области.
Foveros
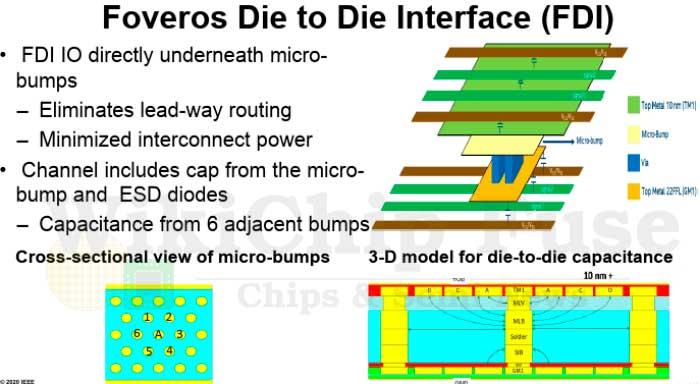
Мы уже много и долго говорили об этой технологии и ее сестрах, поэтому мы пропустим теоретическую часть, чтобы кратко прокомментировать, как Intel планирует расположить свои чипы по вертикали. У нас будет два основных слоя плюс LPDDR4X Оперативная память Память чипсы, что впечатляет.
Матрица «лицом к лицу» связана с подложкой LFF 22 нм с помощью микропробежек размером 50 мкм, что, в свою очередь, связано с основным пакетом. Воспоминания хранятся чуть выше ядер и их 10 нм + матрица с 350 микрон TSV для соединения. Таким образом, в итоге мы имеем 5 слоев на чипе высотой 12 мм2 и 1 мм.
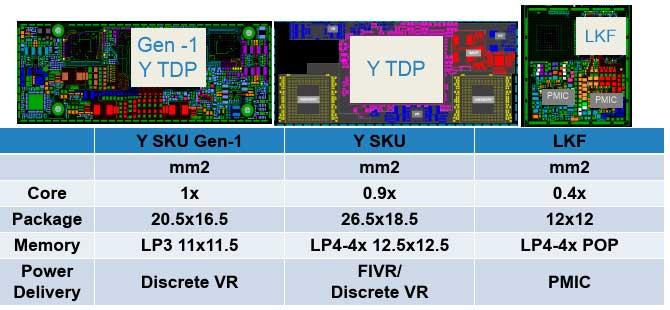
Интерфейсы связи создаются с использованием того, что Intel называет FDI или Foveros Die Interface, где максимальная скорость, с которой они достигают между матрицами, составляет 500 т / с и за полосу. Учитывая, что у него более 200 дорожек с одинаковыми тактовыми частотами, мы имеем поразительную полосу пропускания для чипа такого размера.
Чтобы закончить этот раздел, следует иметь в виду, что это положение диет заканчивается с другим форм-фактором, который включает в себя источник питания через TSV, который был назван PMIC и не имеет ничего общего с мобильными контроллерами напряжения серий U и Y.
LakeField, будущее 3D-стекирования

Как мы уже видели с Co-EMIB и ODI будущее компании заключается в улучшении того, что существует с LakeField. Первым шагом будет повышение эффективности и затрат, постепенное внедрение различных улучшений, которые требуют новых систем создания САПР, источников питания, ОУР, целостности сигнала и длительной работы и т. Д.
То, что Intel будет искать в течение короткого периода времени, - это объединение ядер с низким энергопотреблением с ядрами с очень высокой производительностью, включая Xe GPU с HBM и все в том же вертикальном 3D-пакете, который предлагает лучшее из всех миров.
