Wczoraj rozmawialiśmy o zaletach Intel miał koniec AMD, gdzie jednym z działów był właśnie dział innowacji. Dowodem na to jest to, co przedstawił Intel w związku z technologią układania w stosy 3D, która utworzy wysokowydajne chipy przyszłości, oczywiście nie bez problemów. Wydaje się, że firma znalazła rozwiązanie prawie wszystkich problemów, które pociąga za sobą ta technologia, dzięki tak zwanej nazwie ODI firmy Intel.
Zanim przejdziemy do wyjaśnienia, na czym polega ta technologia, musimy zrozumieć, jakie były powody, dla których Intel ją opracował, jakie były problemy i gdzie były ograniczenia.

Tylko w ten sposób możemy zrozumieć złożoność tej całej sprawy i sposób, w jaki firmie udało się rozwiązać te problemy w bardzo inteligentny sposób.

Przede wszystkim, aby stworzyć schemat mentalny, Intel współpracuje obecnie z trzema różnymi technologiami stosowymi, od najmniej do najbardziej skomplikowanych: EMIB, Foveros i CO-EMIB.
Pierwsza to tak zwana technologia 2.5D, druga to pierwsza prawdziwa generacja 3D, a druga łączy obie w celu zaoferowania znacznie bardziej złożonych produktów. Chociaż widzieliśmy je już osobno, dokonamy szybkiej oceny wszystkich z nich, aby ponownie znaleźć się w innym miejscu.
IntelEMIB
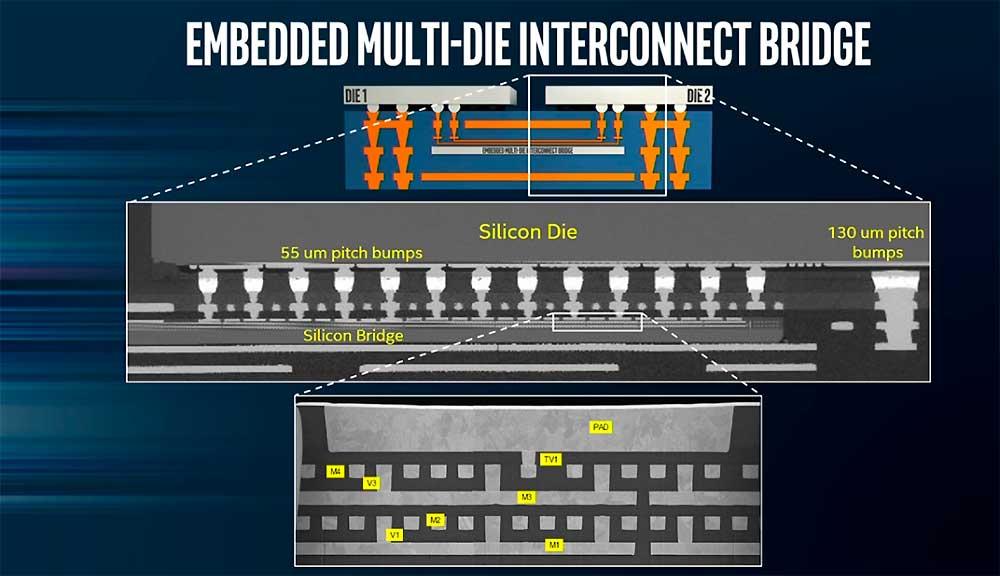
Skrót od Embedded MultiInterconnect Bridge, jest to znany nam system 2.5D, ponieważ zadebiutował Kaby Lake G i zawierał matrycę Intel z odpowiadającymi jej rdzeniami, pamięcią podręczną, rejestrami itp., matrycę należącą do AMD poprzez RX Vega M i stos 4 GB HBM2, wszystko w jednym urządzeniu pośredniczącym, które zostało przylutowane do płyt głównych laptopów.
EMIB jest zatem technologią interkonektu na średnim poziomie, która pozwala wydobyć pełną wydajność każdego układu zawartego w interposer.
Intel Fovero
To pierwszy krok w rewolucji, w którym zobaczymy prawdziwe układanie 3D. To nic innego jak połączenie różnych matryc w pionie, jedna na drugiej, zamiast poziomo, jak dotychczas.
Tak nazywa Intel Twarzą w twarz i reprezentuje szereg dość interesujących, a jednocześnie nieco logicznych problemów. Pierwszy to problem elektryczny, ponieważ konieczne jest doprowadzenie wystarczającej ilości energii do górnej matrycy i aby to zrobić, konieczne jest przejście przez pośrednią / te. Zostało to częściowo rozwiązane za pomocą połączeń TSV, ale są one niechętne do dostarczania dużych ilości napięcia i chociaż dodanie większej ilości można rozwiązać, istnieje problem polegający na tym, że najdroższy obecnie układ 3D dokładnie dodaje TSV jakości i objętości.
Wreszcie Intel ma problem z temperaturą. Górna matryca może być chłodzona, ale jednocześnie stanowi opór cieplny dla dolnych, ponieważ przy każdej matrycy pionowej górna przeszkadza w przekazywaniu ciepła i generuje problem z łańcuchem.
Intel CO-EMIB
Jest to w zasadzie połączenie, które można nazwać w jakiś potoczny sposób, między EMIB i Foveros. Jest to układanie w stos 3D, w którym stosowana jest długość pozioma, a zatem w pewien sposób łagodzi problemy obu, ale ich nie rozwiązuje.
Dlatego Intel musiał wymyślić nową technologię, która byłaby kompatybilna ze wszystkimi trzema modelami opakowań, a jednocześnie położyła kres wszystkim problemom, o których mówiliśmy, i właśnie w tym miejscu pojawia się ODI.
ODI firmy Intel
ODI to skrót od Wielokierunkowy interkonekt i nie jest to technologia sama w sobie, ale ich grupa, czyli ODI obejmuje szereg konkretnych rozwiązań, które mogą z czasem wzrosnąć lub ewoluować jako takie.
Jego główna funkcja opiera się na dostarczaniu energii i ma na celu wyeliminowanie problemów EMIB i Foveros, ponieważ robienie tego domyślnie kończy problemy CO-EMIB.


Wszystko opiera się na tym, co nazywa Intel Przepływy opakowań 3D , które są niczym więcej niż wewnętrznymi ścieżkami połączeń wzajemnych w celu poprawy dostarczania energii i jednocześnie poprawy odprowadzania ciepła za pomocą jednego rodzaju technologii.


W tej chwili Intel ODI jest podzielony na dwa ogólne typy a te z kolei stanowią dwie uzupełniające się technologie, co daje w sumie cztery warianty. Wariant Typu 1 koncentruje się na problemach pomiędzy dolną i górną matrycą, podczas gdy Typ 2 robi to między dolnymi matrycami, które są, pionowo mówiąc, całkowicie poniżej górnej matrycy.
To znaczy pakiet Foveros i pakiet CO-EMIB, do którego logicznie wchodzi Intel EMIB. Wyjaśniliśmy to, że bardziej szczegółowo omawiamy różne typy.
Intel ODI Typ 1
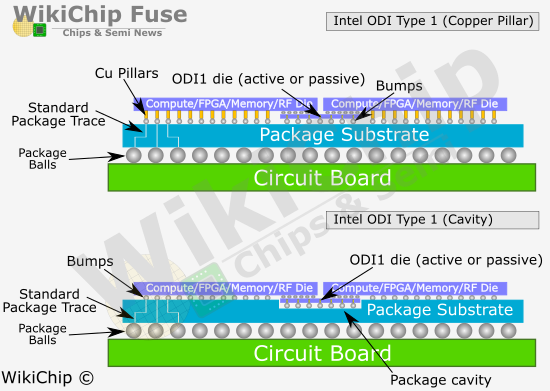
Pierwszą rzeczą, którą musimy sobie wyobrazić, jest to, że matryca, o której będziemy rozmawiać, ma różne rozmiary, co jest ważne, ponieważ sposób ich łączenia różni się ze względu na ich wymiary. Mając to na uwadze, musimy wyobrazić sobie większą matrycę, która znajduje się poniżej dwóch mniejszych górnych matryc, lub w najbardziej ekstremalnym przypadku jest to większa matryca, która znajduje się poniżej innej mniejszej matrycy, która logicznie nie obejmuje całego dolnego obszaru.
Aby dać mniej lub bardziej proste porównanie, jest to efekt piramidy: dolna podstawa ma zawsze większy obszar niż górna, z tą różnicą, że tutaj jest tylko jedna kostka, a na górze może mieć jedną lub kilka mniejszych, ale nigdy nie osiągają wielkości tak dużej jak dolna.
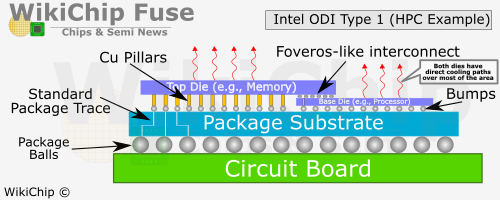
Zaletą tego jest to, że Intel zaprojektował system w taki sposób, że dolna matryca pokrywa tylko część górnej matrycy, w której wymagane jest połączenie między nimi. Powód tego ma swoją logikę: eliminujesz wady TSV i zachowujesz wszystkie Fovera. Ponieważ używana jest tylko część połączenia między matrycami, Intel może wykonać aktywne lub pasywne ODI typu 1.
Oznacza to, że w przypadku bierności ogranicza się tylko do połączenia obu matryc, ale jeśli jest aktywny, działa jako nadajnik danych między połączeniami, co jest bardzo przydatne, jeśli chcesz dodać z HBM stosy do zewnętrznej pamięci podręcznej lub an iGPU . Dlatego, wracając do schematu mentalnego, jeśli kilka matryc o różnych rozmiarach jest używanych za pomocą ODI 1, wszystkie z nich mają dostęp do lepszego rozpraszania ciepła, gdzie IHS będzie musiał w niektórych przypadkach być specyficzny, ale dostęp został osiągnięty. bezpośrednio do niego, a zatem problemy temperaturowe zostały rozwiązane.
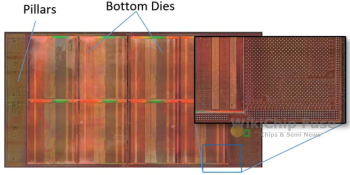
Jest to ważne, ponieważ jeśli spojrzymy na obie matryce z punktu widzenia zenitu, byłaby tylko część z nich, która byłaby połączona, niezbędna, podczas gdy reszta matrycy jest niezależna i pozostaje w powietrzu w każdym przypadku, z oczywiście dwie różne wysokości i właśnie to odróżnia go od EMIB jako technologii.
Nie wspominając już o tym, że połączenie obu matryc musi być wykonane między innymi za pomocą kompresji termicznej.
Intel ODI Typ 2
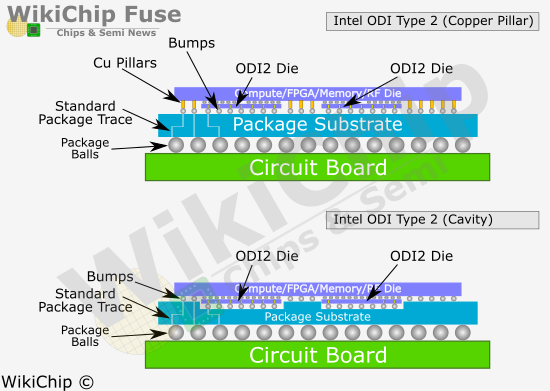
Tutaj problem nasila się, ponieważ dolna matryca jest zawsze poniżej górnej matrycy, to znaczy, że nie ma części matrycy, która jest poniżej, która wystaje z tej, która jest powyżej. Ma to wadę cieplną, ale jednocześnie ma wyraźniejszą zaletę: dolną matrycę można umieścić dokładnie tam, gdzie jest to wymagane w porównaniu z górną matrycą, a liczba połączeń może być znacznie wyższa.
Ta technologia koncentruje się na łagodzeniu problemów związanych z wydajnością i połączeniami między matrycami, w których wydajność przełożonego jest zawsze zmaksymalizowana, takich jak lepsze połączenia wejściowe i wyjściowe, większa prędkość w pamięci podręcznej, Outsourcing bez kary i bez końca. możliwości.
Możesz zrobić we / wy w stylu Zen 2, pozostawiając skrytki poza rdzeniami w różnych kościach, tworząc nienaruszone rdzenie i na trzech różnych poziomach bez utraty wydajności, ponieważ są one bezpośrednio połączone ze sobą poprzez fizyczne związki z TSV. Zalety tego są tak oczywiste, że absurdem jest nawet ich komentowanie.
Tutaj problemem jest temperatura, ale w przypadku ODI typu 2 celem jest umieszczenie matrycy o najniższym zużyciu energii w dolnej części i skalowanie w pionie, aż do umieszczenia matryc, które generują więcej ciepła w górnej warstwie, aby można było w lodówce z IHS, co daje naprawdę niesamowite CPU opcje konfiguracji i umożliwia segregację w celu zwiększenia wydajności.
Jak powiedzieliśmy, ODI Type 1 i Type 2 mają dwie różne wersje: Filar miedziany i pustka , w którym w pierwszym zastosowano miedziane słupy w celu skompensowania większej wysokości, podczas gdy w drugim podłoże formowałoby się do dolnej matrycy, umożliwiając stosowanie wypukłości zamiast słupów.
Intel ODI może mieszać oba typy, aby zaoferować bardziej złożone procesory
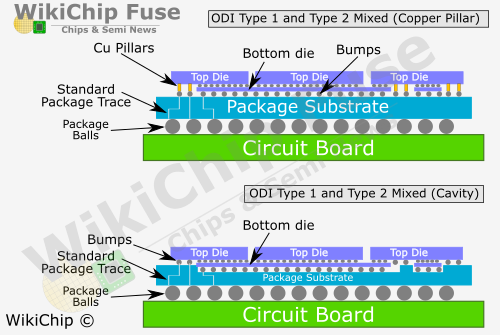
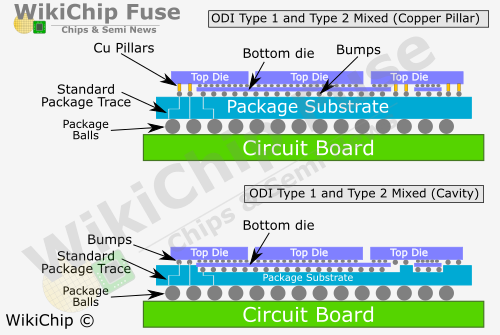
Kolejną zaletą ODI jako technologii jest to, że nie jest ona wyłączna, to znaczy, że oba typy mogą być używane z ich dwiema wersjami na tym samym procesorze. Dlatego też modułowość które zobaczymy w przyszłych procesorach, jest tak dużego kalibru, że złożoność ich konstrukcji będzie głównym wyzwaniem dla Intela.
Najbardziej oczywiste pytanie jest jednocześnie najbardziej istotne: kiedy zobaczymy te procesory na rynku? Naprawdę trudne pytanie. Należy pamiętać, że ODI jako technologia ma zaledwie kilka miesięcy, jest obecnie wdrażana i musi ulec poprawie w zakresie uproszczenia procesu, ale Intel odważył się podać przybliżone daty: 2022 lub 2023.
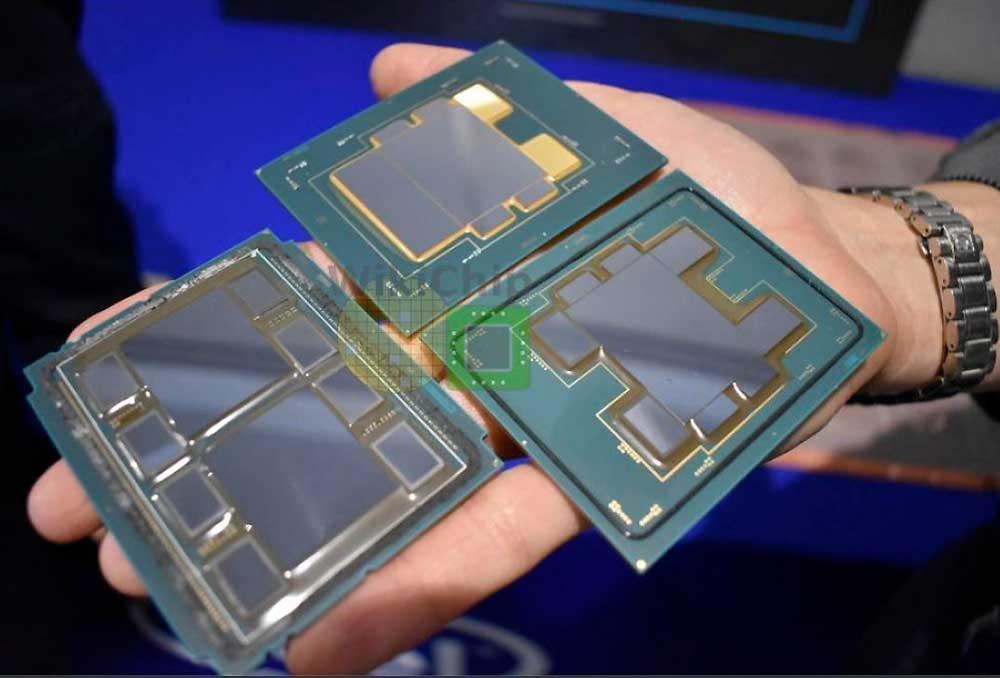
ODI jako technologia zdoła skrócić terminy, ponieważ rozwiązuje dwa główne problemy trzech technologii Intela, więc pierwsze procesory (oczywiście nie muszą to być komputery stacjonarne) można było zobaczyć w produkcji w 2024 r., Będąc naprawdę optymistami , ponieważ Jak to często bywa, najpierw wypuszczane są mniej wydajne wersje, a gdy proces i produkcja są dopracowywane i ulepszane, wówczas oferowana jest wersja o wysokiej wydajności.
W każdym razie, to nie jest science fiction, to rzeczywistość, namacalna, która już była na rynku Kaby Lake G i Stratix 10 i która jest niewątpliwie przyszłością procesorów, która jest znacznie większą rewolucją niż Multi die lub MCM ze względu na swoją złożoność, jest ostatecznym krokiem, aby móc złagodzić ścianę, którą znajdziemy za pomocą procesów litograficznych w 2030 roku, i to może być bez wątpienia poprzednim krokiem do bardziej złożonych technologii, które pozostawiają to, co obecnie mamy w pieluchach na rynku.
