При производстве микросхем узловых технологий и Закон Мура В настоящее время наблюдается полный и очевидный спад, производители микросхем и дизайнеры продолжают искать новые творческие решения, позволяющие масштабировать устройства и повышать производительность. Передовые технологии инкапсуляции - одна из тех областей, в которых мы великие инновации в последние годы, например, введение кремния посредники , интеграция памяти HBM в сам чип или переход к модульному принципу с помощью чиплетов. Сегодня мы поговорим с вами о Технология TSMC LSI , с помощью которых они намерены строить свои чипы в будущем, и которые могут изменить к лучшему то, как работает эта отрасль.
Кремниевые переходники создают проблемы с затратами, поскольку они очень дороги и требуют довольно большого количества кремния, в то время как конструкции чиплетов с использованием традиционной упаковки на органических подложках ограничены полосой пропускания ввода / вывода и энергоэффективностью. Одним из решений этой проблемы стало внедрение в промышленность промежуточных кремниевых матриц, которые соединяют два логических чипа вместе, но только в ограниченном объеме и без использования той же площади, что и полный кремниевый переходник. IntelEMIB В последнее время больше всего говорят о реализации этой технологии (Embedded Die Interconnect Bridge).
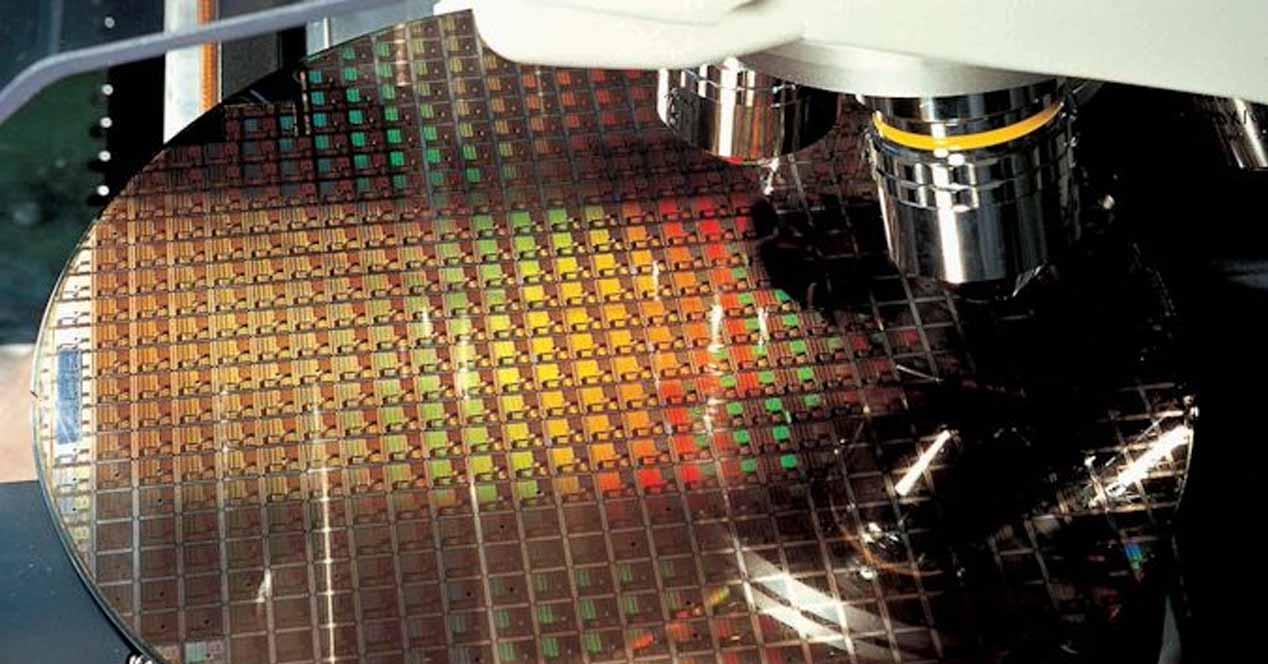
TMSC LSI, будет ли это будущим отраслевых микросхем?
Во время технологического симпозиума TSMC 2020 года тайваньский производитель подробно рассказал о своем собственном варианте такой технологии под названием Local Si Interconnect (LSI), который будет предлагаться для технологий инкапсуляции InFO и CoWoS в форме InFO-L и CoWoS-L.
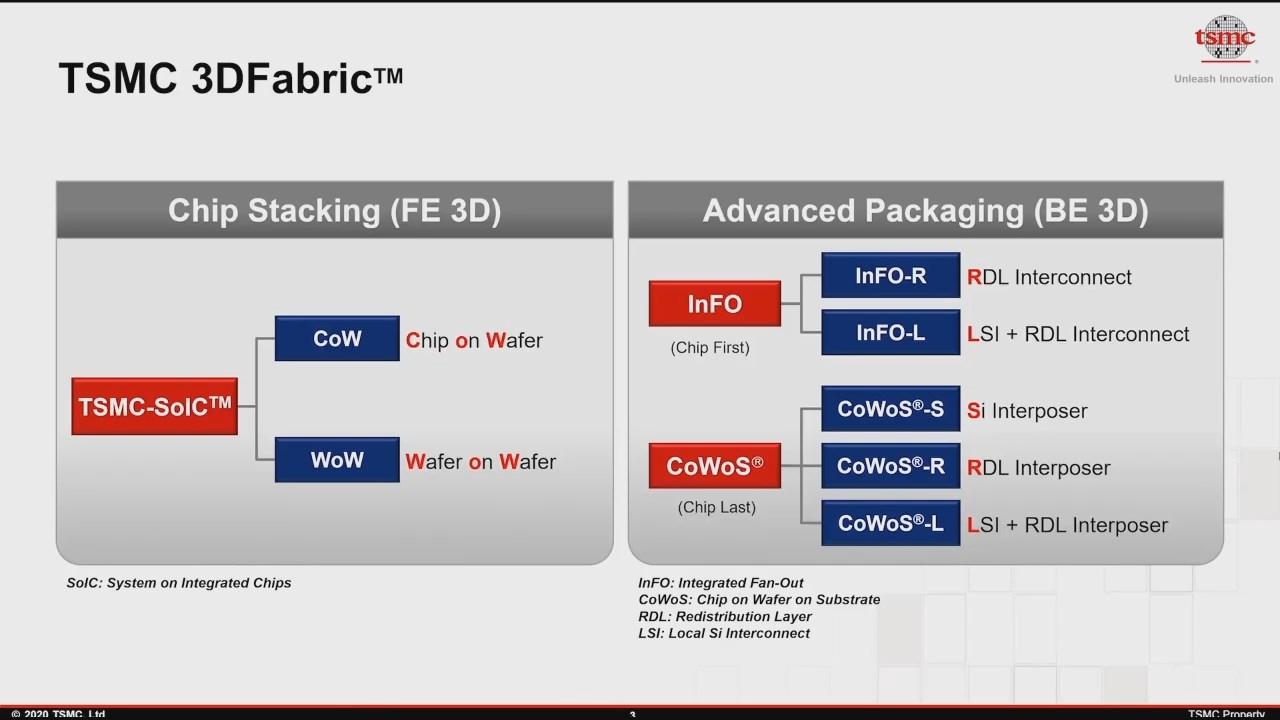
Новые достижения являются частью того, что TSMC теперь называет своим 3D Ткань технология упаковки, которая предлагает довольно универсальный набор вариантов инкапсуляции и интеграции, включая, конечно же, SoIC, InFO и CoWoS.
Краткое объяснение для наших читателей, которые не знакомы с этими терминами: SoIC (System on Chip Integrated) - это технология интеграции гибридного соединения и стекирования микросхем TSMC, которая позволяет объединять несколько массивов микросхем вместе, что делает ширину полосы чрезвычайно большой и имеет стык между кристаллами из кремния с низким потреблением. В настоящее время эта технология не имеет аналогов в отрасли.
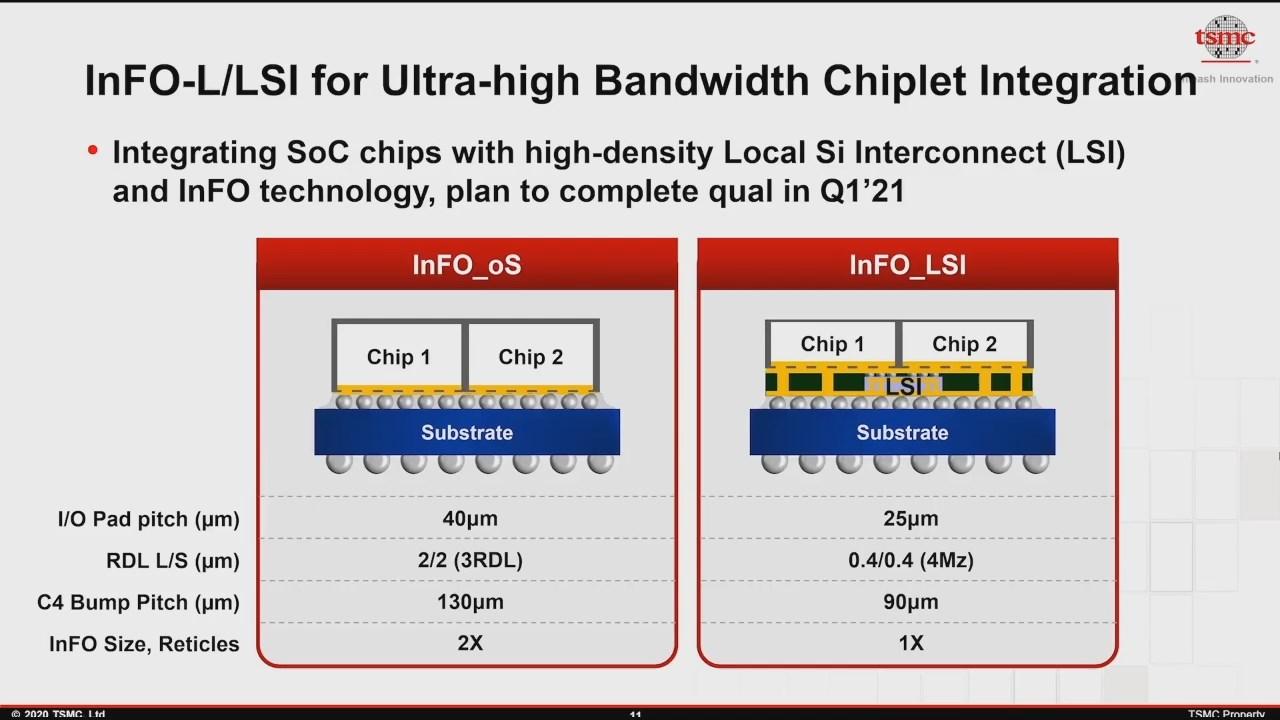
InFO - это технология упаковки или инкапсуляции вентиляторов TSMC, при которой кристалл снимается с кремниевой пластины и помещается на другую несущую пластину, на которой строятся более крупные структуры, такие как медный RDL. (перераспределительный слой), а затем несущая подложка.
Вариант TSMC InFO с интеграцией LSI называется InFO-L или InFO-LSI и следует аналогичной структуре с новым добавлением этого микросхемы локального кремниевого межсоединения для связи между обоими микросхемами.
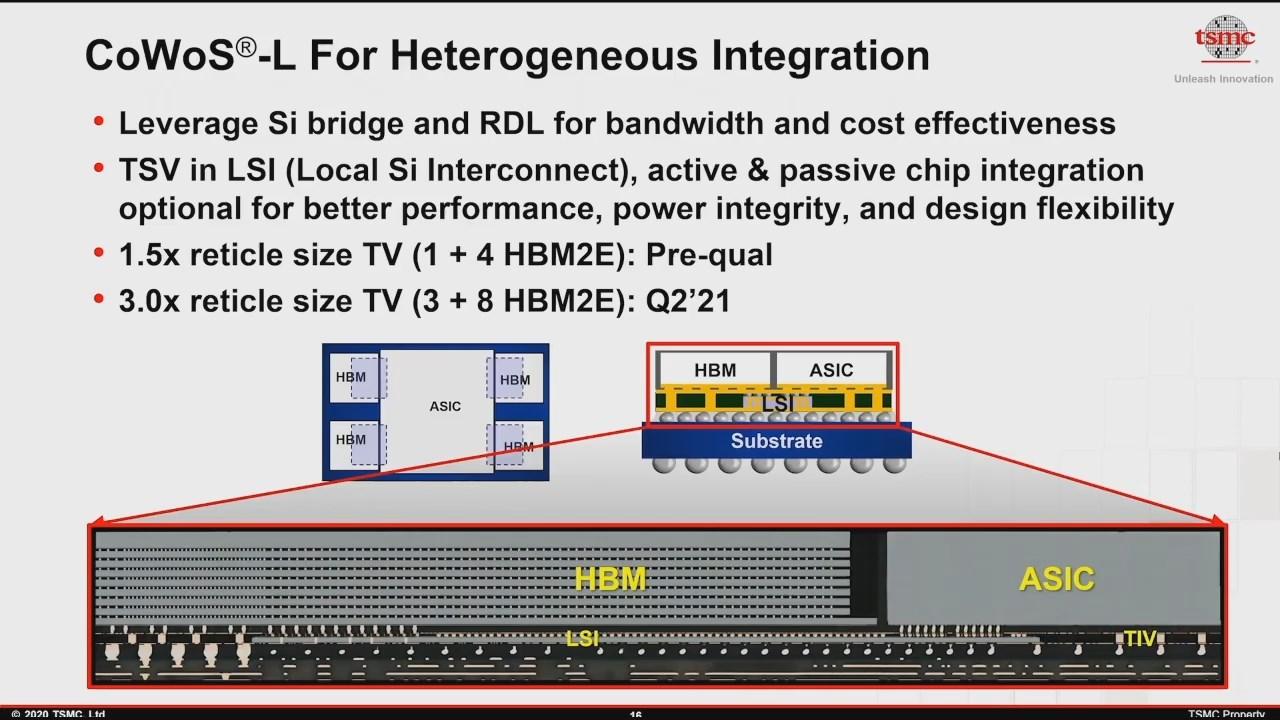
CoWoS от TSMC (Chip-on-Wafer-on-Substrate) изначально описывалась как технология упаковки кремниевого интерпозера 2.5D компании, которая в настоящее время все еще находится в соответствии со спецификацией CoWoS-S, но в то же время охватывает и другие технологии инкапсуляции. Как говорится в описании, RDL сначала строится на базовой подложке, и только на последнем этапе в набор добавляется кремниевый чип.
CoWoS-L - это новый вариант технологии упаковки микросхем TSMC, добавляющий локальное кремниевое межсоединение, которое используется в сочетании с медным RDL для достижения большей пропускной способности, чем при использовании реализации упаковки RDL. (CoWoS-R), а также имеет более низкую стоимость, чем если бы использовался полностью кремниевый переходник (CoWoS-S). Другими словами, с этой технологией инкапсуляции вы получаете лучшая производительность при более низкой цене .
TSMC описывает LSI как активную или пассивную микросхему (в зависимости от потребностей разработчиков микросхем и их бюджета). Металлургический завод TSMC планирует завершить квалификацию InFO-L в первом квартале 2021 года, в то время как CoWoS-L в настоящее время находится в процессе предварительной квалификации. Ожидается, что технологии межсоединений на основе кремниевых мостов, такие как LSI и EMIB, позволят создать высокопроизводительные микросхемы по более низкой цене как для разработчиков, так и для потребителей.
Вкратце: чипы с более высокой производительностью и более дешевыми, что должно переводить (для пользователя) в более мощные и дешевые процессоры .