În timp ce se realizează cip tehnologii nod și Legea lui Moore sunt într-o încetinire totală și aparentă, producătorii de cipuri și proiectanții continuă să caute soluții noi creative pentru a permite scalarea dispozitivelor și performanța să crească în continuare. Tehnologiile avansate de încapsulare sunt unul dintre acele domenii pe care le-am văzut mari inovații în ultimii ani, cum ar fi introducerea siliciului interpozitori , integrarea memoriei HBM pe cipul în sine sau trecerea la modularizare cu cipete. Astăzi vom vorbi despre tine Tehnologia LSI a TSMC , cu care intenționează să-și construiască jetoanele în viitor și care se pot schimba - în bine - cum funcționează această industrie.
Interpozitori de siliciu prezintă provocări legate de costuri, deoarece sunt foarte scumpe și necesită o cantitate destul de mare de siliciu, în timp ce proiectele de chiplet care utilizează ambalaje convenționale pe substraturi organice sunt limitate de lățimea de bandă de intrare / ieșire și de eficiența energetică. O soluție la această problemă a fost introducerea în industrie a matricilor intermediare de siliciu care conectează două cipuri logice împreună, dar numai într-un domeniu limitat și fără a utiliza aceeași amprentă ca un interpozitor de siliciu complet. IntelEMIB (Embedded Die Interconnect Bridge) a fost cea mai discutată implementare a acestei tehnologii în ultima perioadă.
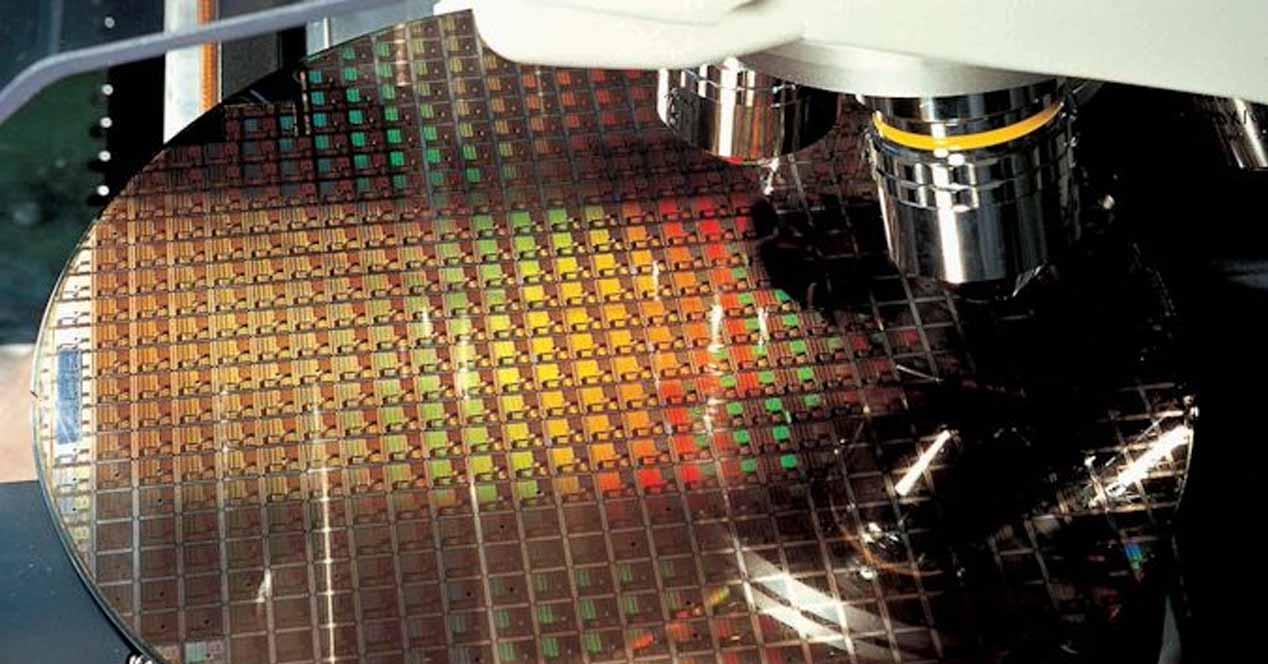
TMSC LSI, va fi viitorul jetoanelor din industrie?
În cadrul Simpozionului Tehnologic 2020 al TSMC, producătorul taiwanez a detaliat propria variantă a unei astfel de tehnologii, denumită Local Si Interconnect (LSI), care va fi oferită pentru tehnologiile de incapsulare InFO și CoWoS sub forma InFO-L și CoWoS-L.
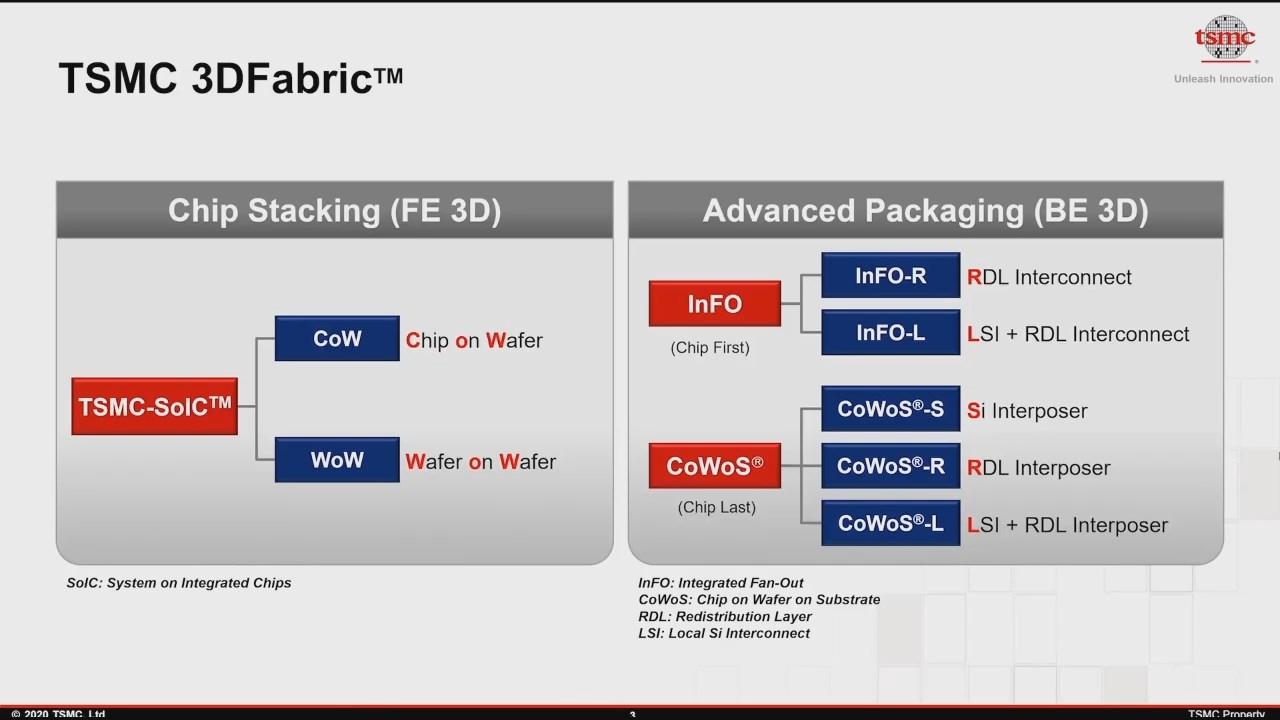
Noile progrese fac parte din ceea ce TSMC numește acum Tesatura 3D tehnologia de ambalare, care oferă un repertoriu destul de versatil de opțiuni de încapsulare și integrare, incluzând, desigur, SoIC, InFO și CoWoS.
O scurtă explicație pentru cititorii noștri care nu sunt familiarizați cu acești termeni: SoIC (System on Chip Integrated) este tehnologia integrării de legare hibridă și de stivuire a cipurilor TSMC, care permite stivuirea mai multor matrice de cipuri, ceea ce face ca lățimea benzii să fie extrem de mare și să aibă o joncțiune între matrițele de siliciu cu consum redus. În prezent, această tehnologie este de neegalat în industrie.
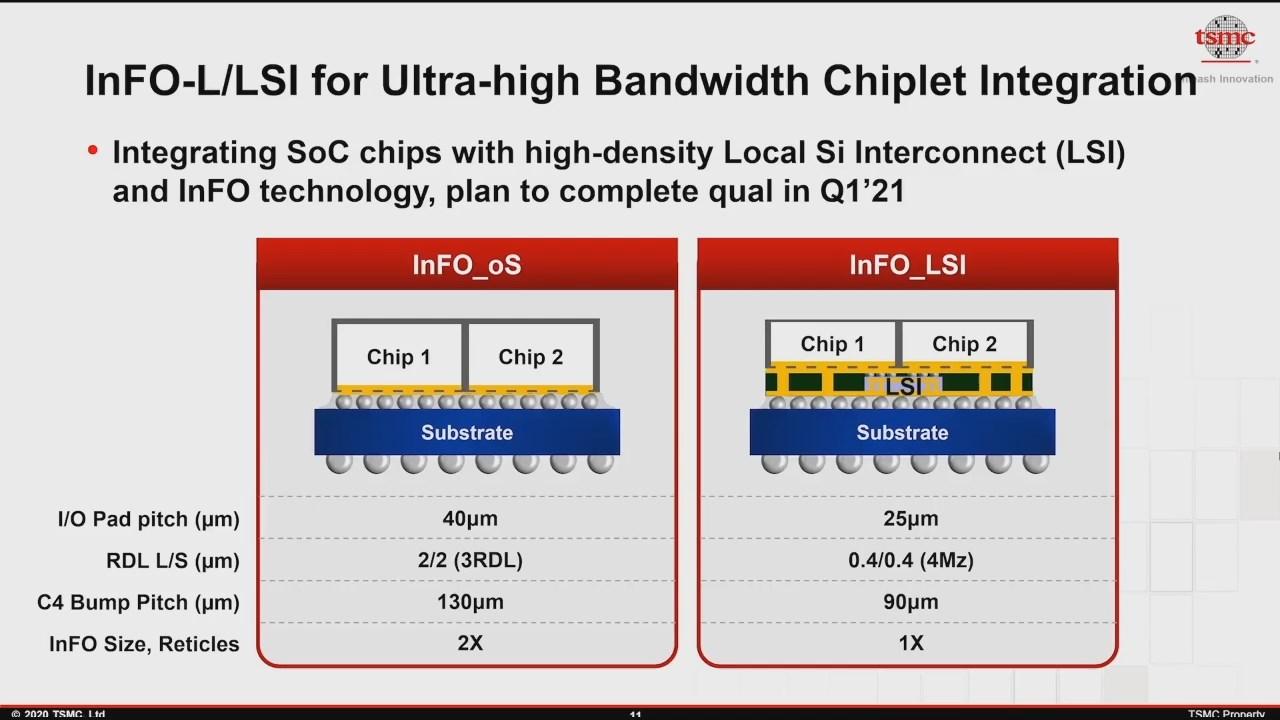
InFO este tehnologia de ambalare sau încapsulare a ventilatorului TSMC, în care o matriță este îndepărtată dintr-o placă de siliciu și plasată pe o altă placă purtătoare, pe care sunt construite structuri mai mari, cum ar fi cuprul RDL. (strat de redistribuire) și ulterior substratul purtător.
Varianta TSMC a InFO cu integrare LSI se numește InFO-L sau InFO-LSI și urmează o structură similară cu noua adăugare a acestui cip intermediar de silicon local de interconectare pentru comunicare între ambele cipuri.
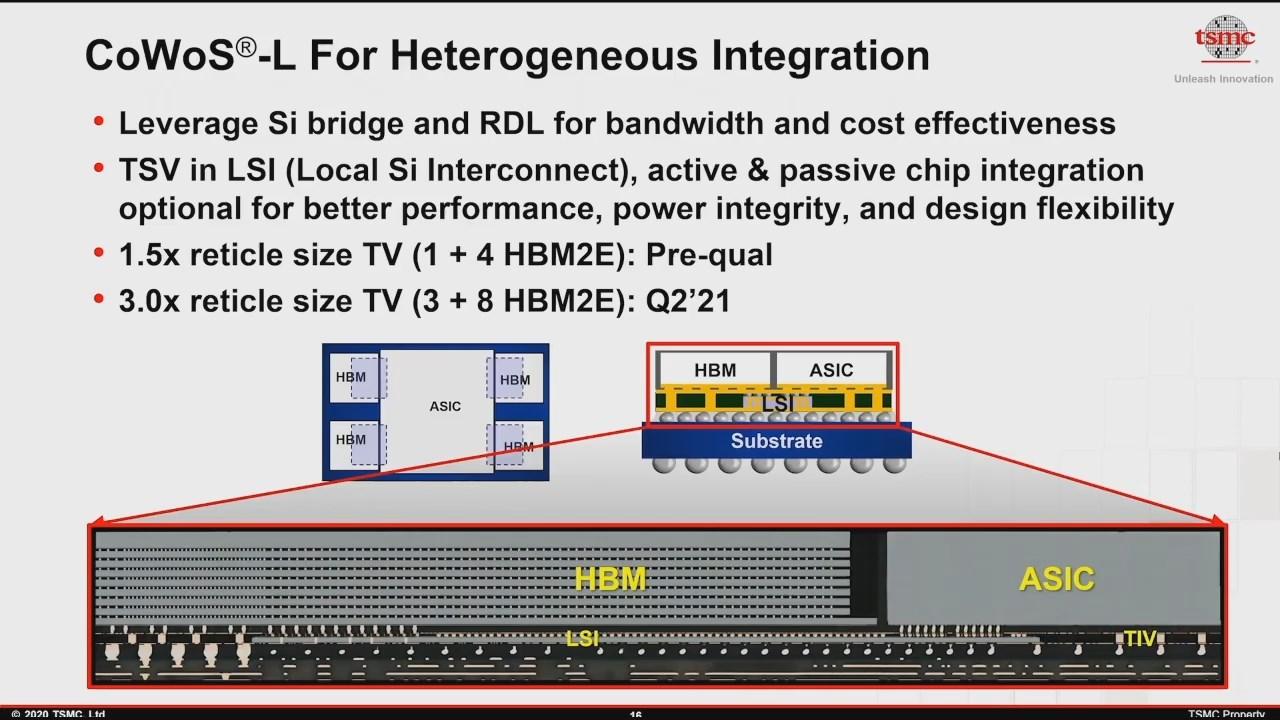
CoWoS (Chip-on-Wafer-on-Substrat) TSMC a fost inițial descris ca tehnologia de ambalare a interpozitorului de siliciu 2.5D al companiei, care este în prezent încă sub specificația CoWoS-S, dar între timp acoperă și alte tehnologii de încapsulare. După cum spune descrierea sa, RDL este construit mai întâi pe suportul de bază și doar ca ultim pas se adaugă cipul de siliciu setului.
CoWoS-L este noua variantă a tehnologiei de ambalare a cipurilor TSMC, adăugând o interconectare de siliciu locală care este utilizată în combinație cu un RDL din cupru pentru a obține o lățime de bandă mai mare decât utilizarea unei implementări de ambalare RDL. (CoWoS-R) și are, de asemenea, un cost mai mic decât dacă s-ar utiliza un interpozitor de siliciu complet (CoWoS-S). Cu alte cuvinte, cu această tehnologie de încapsulare veți obține performanță mai bună la un cost mai mic .
TSMC descrie LSI ca un cip activ sau pasiv (în funcție de nevoile proiectanților de cipuri și de bugetul acestora). Topitorul TSMC se așteaptă să finalizeze calificarea InFO-L în primul trimestru al anului 2021, în timp ce CoWoS-L se află în prezent într-un proces de precalificare. Se așteaptă ca tehnologiile de interconectare a punților din silicon, cum ar fi LSI și EMIB, să furnizeze modele de cipuri de înaltă performanță la un cost mai mic atât pentru proiectant, cât și pentru consumator.
Pe scurt: cipuri cu performanțe mai mari și mai ieftine, ceva care ar trebui să se traducă (pentru utilizator) în procesoare mai puternice și mai ieftine .