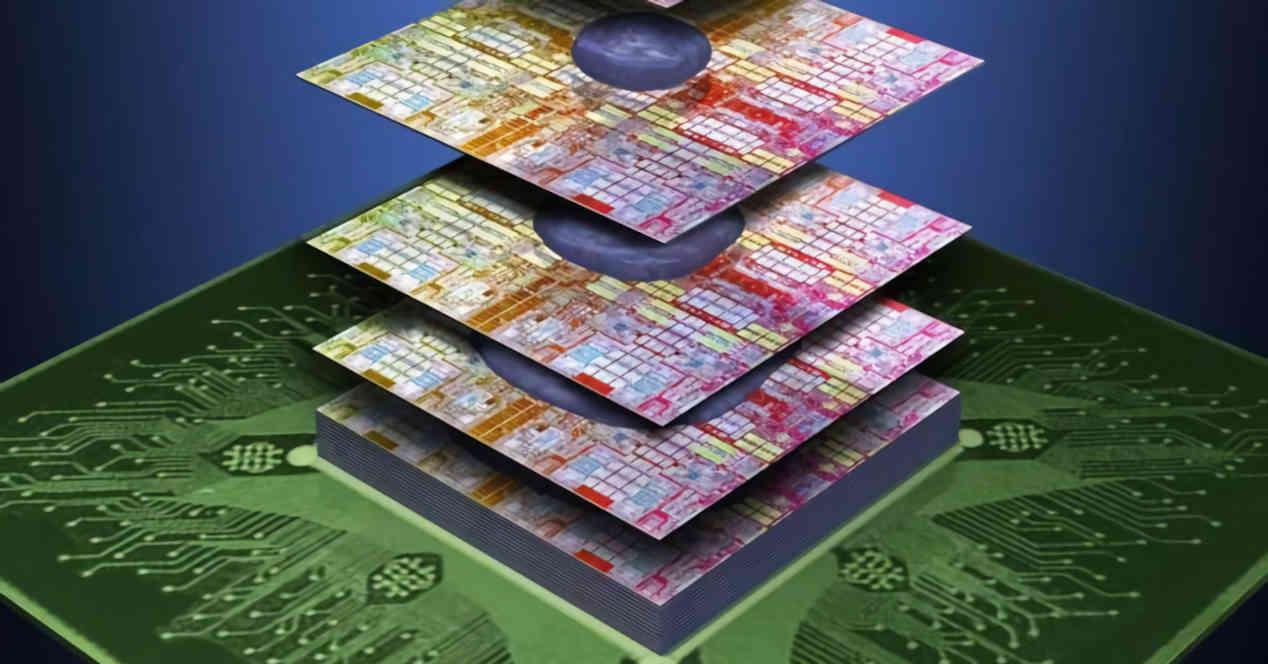
Intel ja AMD ovat ilmoittaneet kaikenlaisten 3DIC-tekniikoiden käytöstä tulevien prosessorien rakentamiseen, ja tämä suuntaus kasvaa tulevina vuosina. Mutta miten tulevat Intel- ja AMD-suorittimet voitaisiin rakentaa tällä tekniikalla? Tässä artikkelissa yritämme valaista, miten nämä tulevaisuuden prosessorit voisivat olla.
Kun käytetään uusia tuotantosolmuja, voidaan nähdä, kuinka kustannukset kasvavat yhä enemmän, mikä pakottaa paitsi ottamaan uusia strategioita uusien prosessoreiden suunnittelun lisäksi myös uusia tapoja rakentaa niitä.
Mitä ymmärrämme 3DIC: ksi?
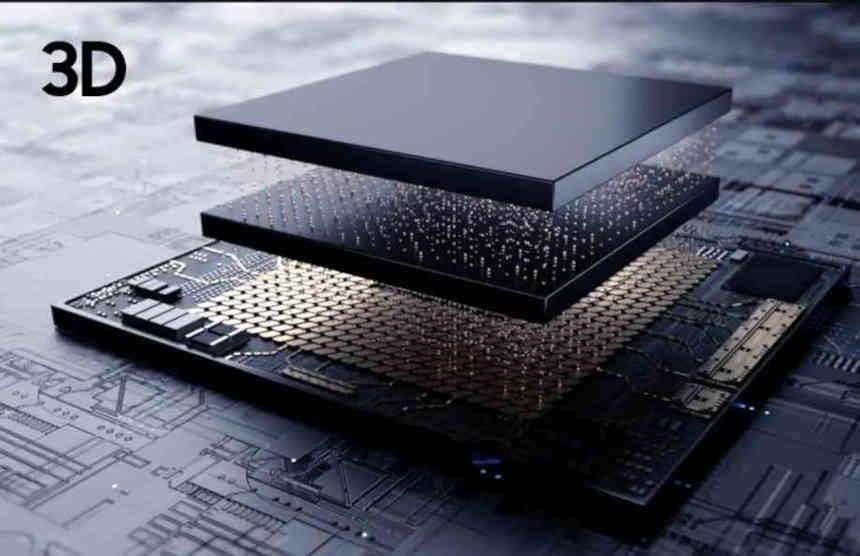
3DIC on lyhenne kolmiulotteisesta integroidusta piiristä, joka on nimi, joka annetaan kaikille prosessoreille tai niiden sarjoille, jotka koostuvat useista erilaisista siruista, jotka on kytketty toisiinsa hyödyntämällä pientä tai TSV: tä. Toistaiseksi PC-laitteistokomponenttien markkinoilla olemme nähneet erilaisten tuotemerkkien 3D-NAND-muistin sekä HBM-muistin eri sukupolvet vain esittelyinä
Yksi 3DIC: n eduista on se, että voimme käyttää useita siruja, joilla on eri valmistussolmut, yhdistetyllä tavalla, tämä on etu, koska kaikkia prosessorin elementtejä ei tarvitse skaalata uuteen valmistussolmuun, koska ne eivät tarjoa korkeampi suorituskyky heille.
Suora die-to-die tai kuinka rakentaa monimutkainen prosessori 3DIC: n avulla
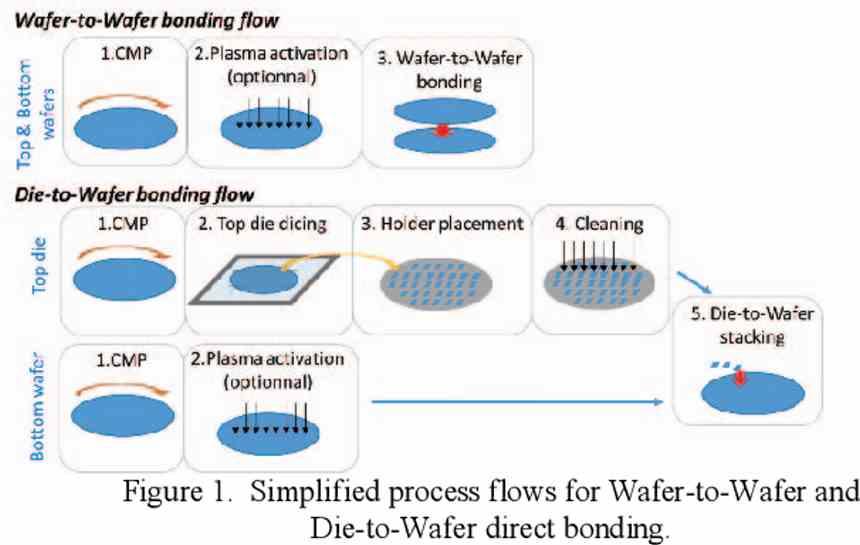
Ajatuksella yhdistää kaksi logiikkasirua yksi kerrallaan 3DIC-rakenteeseen hyödyntämällä vertikaalista TSV-liitäntää, on mahdollista muuttaa täysin kaikki prosessoriteollisuuden sektorit. Puhelimen keskusprosessorina toimivista erittäin pienitehoisista SoC: ista datakeskuksiin erikoistuneisiin huippuluokan siruihin.
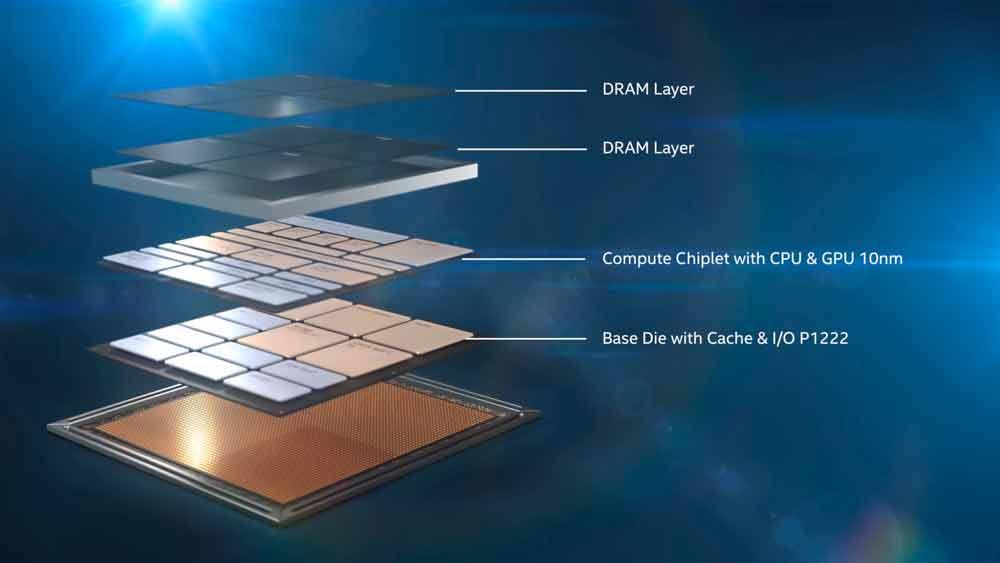
Ajatus prosessorin erottamisesta kahdeksi tai useammaksi pystysuoraan kohdistetuksi osaksi on jotain, mitä olemme jo nähneet Intel Lakefield -ohjelmassa, jossa prosessori ytimet ja Northbridge on erotettu Southbridgestä eri siruilla ja käyttämällä valmistussolmuja. eri. Mutta meidän pitäisi alkaa tarkastella joitain SoC- ja jopa CPU-malleja.
Mutta Intel-arkkitehtuuri ei ole ainoa tapa rakentaa nykyaikainen prosessori 3DIC-tekniikkaa käyttäen, mutta on olemassa myös toisen tyyppinen kokoonpano, jossa prosessorin ytimet ja saman prosessorin "uncore" erotetaan kahteen tai useampaan eri siruun, jotka on kytketty toisiinsa. TSV.
Suoritinarkkitehtien suurin haaste tällä hetkellä on prosessorin tiedonsiirron energiakustannukset, jotka puhumassamme kokoonpanossa pienenevät huomattavasti, joten 3DIC ei ole vain Intelin ja AMD: n tulevaisuuden panos, vaan se on myös jotain, jonka aiomme nähdä ARM maailmassa.
Intelin tai AMD: n mahdollinen tuleva 3DIC-prosessori

Otamme esimerkkinä esimerkkinä Zen 2: een ja Zen 3: een perustuvat työpöydän prosessorit, jotka jakavat ytimen, ytimen, elementin, joka tunnetaan myös nimellä Northbridge, ytimet, vaikka AMD kutsuu sitä skaalattavaksi datakankaaksi. Aiomme käyttää tätä arkkitehtuuria, koska siinä on hyvin selkeä komponenttien jako.
AMD tai Intel voisi vapauttaa tulevan prosessorin, jossa näennäisesti näyttäisimme olevan monoliittinen kokoonpano, mutta todella 3DIC-prosessori, jossa pisteet ovat eri pinossa kuin eri ytimet.
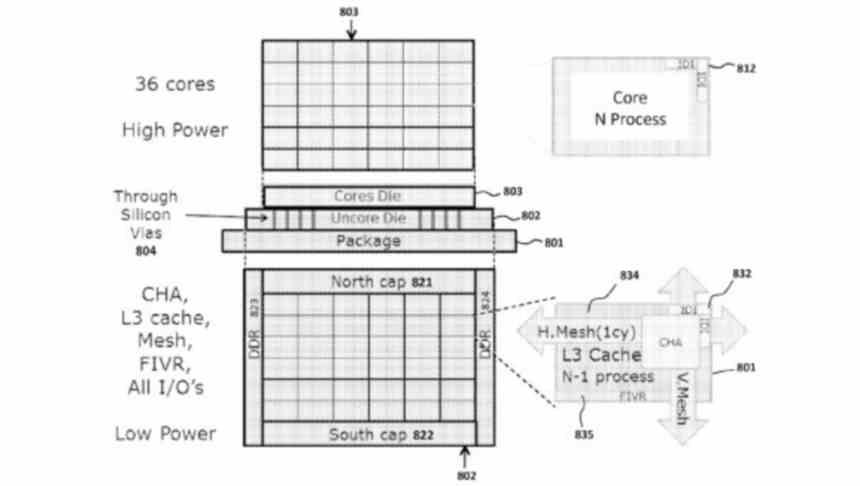
Tämä tarkoittaisi, että CCD: n tai Chipletien ja SDF: n välinen yhteys olisi paitsi suorempi ja siten pienemmällä latenssilla myös kuluttava vähemmän, koska AMD: n tai Intelin olisi mahdollista käyttää suurempaa määrää nastat pienemmällä nopeudella, mutta menettämättä kaistanleveyttä erilaisten ytimien kommunikoimiseksi muun prosessorin kanssa, mikä puolestaan antaa mahdollisuuden lisätä huomattavasti eri suorittimien suorituskykyä wattia kohti.
Ajatus prosessorien jakamisesta usealle tasolle mahdollistaa esimerkiksi monisydämisten järjestelmien rakentamisen, jotka ylittävät kahdeksan ytimen samalla sirulla, ja niiden välisen tiedonsiirron riittävällä nopeudella, hyvällä viiveellä ja kuluttaa hyvin vähän energiaa verrattuna nykyisiin malleihin.
Mitä haittoja Intel ja AMD kohtaavat 3DIC: n käyttöönotossa?

Suurin kompromissi on 3DIC-prosessorin valtavat kustannukset, mikä vaatii lisävalmistusvaiheita, mutta suurin kompromissi on terminen pysähtyminen, joka tapahtuu, kun kaksi komponenttia on niin lähellä, että yhden lämpötila on. se vaikuttaa toisen suorituskykyyn, ei anna komponenttien saavuttaa kellotaajuuksia, jotka ne voisivat saavuttaa erikseen ja jopa 3DIC-kokoonpanossa.
Tämän vuoksi nämä kokoonpanot vaativat myös paljon monimutkaisempia ja kalliimpia jäähdytysjärjestelmiä, jotka yhdessä vievät ne pois kotijärjestelmistä ja tekevät niistä ihanteellisia kaikenlaisille palvelimille, mutta paradoksaalisesti ne ovat myös PostPC-laitteiden SoC: n tulevaisuus, Ne ovat kooltaan rajoitettuja eivätkä ne voi laajentua vaakatasossa, joten ne voivat tehdä sen vain pystysuunnassa.
Syynä tähän on se, että jokaisen uuden solmun kanssa ei vain kasvaa jokaisen kiekkomillimetrin neliömääräinen hinta, vaan on myös yhä vaikeampaa rakentaa suurempia ja suurempia prosessoreita ilman vaarallista vikaantumisastetta. Kaikki tämä pakottaa useimmat mallit siirtymään yhdestä valtavasta monoliittisesta sirusta useisiin pystysuoriin siruihin, vain siksi, että kiekkokohtaiset kustannukset ovat niin korkeat, että edes 3DIC-valmistuksen korkeat kustannukset eivät ole este.